硬金 PCB 表面處理:實現卓越的耐磨性與接觸性能
1 分鐘
- 硬金 vs. ENIG 與軟金:關鍵差異
- 硬金最佳化設計考量
- 硬金表面處理的精密製造
- JLCPCB 打造高品質硬金 PCB 的專業實力
- 常見問題(FAQ)
表面處理並非全都相同,當你面對的是反覆插拔的零件時,這一點更是顯而易見。硬金是最常見的處理方式,當 PCB 必須在退役前完成數百甚至數千次插拔時,基本上就是在鎳屏障層上電鍍一層堅硬的金合金。最具代表性的例子就是邊緣連接器,又稱金手指。這些微型卡邊緣接點會插入主機板、背板與測試板上的對應連接器,每次碰撞都會造成些微磨損。

若使用典型的 ENIG 處理(僅 0.05–0.1 µm 的薄金層),只需幾十次插拔就會把金磨穿,露出底下的鎳,再來是銅,導致接觸電阻上升、氧化與奇怪的連接失效。硬金解決方案採用更厚的金層(通常 0.5–1.5 µm,有時達 2.5 µm)並摻入少量鈷或鎳,使其堅硬。這樣的厚度與硬度組合,讓硬金接點可承受 500–1000 次以上的插拔,並在整個壽命期間保持低且穩定的接觸電阻。其他常見應用包括薄膜按鍵接點、針床治具上的測試點、可變電阻與開關的滑動接點,以及任何會反覆摩擦的接觸面。
需要超越標準處理之耐久性的應用
除了插拔型連接器外,凡需在長期機械應力下維持接點可靠度的場合,也必須使用硬金。工業控制系統的卡籠架構採用金手指邊緣連接器,需在 15–20 年間定期維護與重組。測試與量測設備的金鍍測試點與探針墊,則需在數百萬次測試週期中維持穩定的接觸電阻。
現場可替換模組(如線路卡、交換模組、光收發器)皆配有邊緣連接器。這些應用中,接觸面處理的壽命直接關係到系統可靠度與維護成本。車用安全系統的高可靠連接器接點也採用硬金;制動、轉向與動力總成的 ECU 在車輛生命週期內都無法承受接點退化,因此儘管硬金價格高昂,仍是合理的投資。
硬金 vs. ENIG 與軟金:關鍵差異
厚度、硬度與脆性的取捨
選擇表面處理時,必須了解硬金、ENIG 與軟金的差異。ENIG(化學鎳金)在 3–6 µm 鎳層上沉積極薄的純金(0.05–0.1 µm),主要目的是在焊接前保護鎳。ENIG 適合焊接平面零件,但耐磨性極差,薄薄一層金幾次摩擦就會耗盡。

軟金(又稱可打線金或 Type III 金)為電鍍純金(純度 99.7 % 以上),厚度 0.5–2.5 µm,延展性極佳,適合打線接合,但硬度低(60–90 HK),不適合滑動接點。
硬金(Type I 或 II)則是電鍍金中摻入 0.1–0.3 % 鈷或鎳,硬度達 130–200 HK Knoop,耐磨性優異且仍具導電性。但厚度超過 2.5 µm 時可能變脆,受應力易裂。
電鍍製程在耐磨上的優勢
電鍍鎳金(電解鎳金)製造的硬金,在耐磨性上優於化學(無電解)製程。電鍍可透過調整電流密度與時間,在 0.25–2.5 µm 間精準控制厚度。鎳底層(通常 2.5–5.0 µm)既是銅擴散屏障,也提供硬基底,避免金層因接觸壓力變形。
此外,電鍍具選擇性,僅在與電鍍匯流排相連之處長金,因此同一塊板可在邊緣連接器做硬金,在焊墊做 ENIG,各取所長。
專業提示: 指定硬金時,務必在製作圖與備註中清楚標示金厚、鎳厚與電鍍區域。規格模糊將導致厚度錯誤或區域錯鍍,代價高昂。
實際專案的成本與性能比較
ENIG 與硬金的成本差距明顯:ENIG 通常讓裸板成本增加 5–15 %,而硬金則增加 20–50 % 甚至更多,視電鍍面積與金厚而定。金料本身即為貴金屬,隨市場波動,厚鍍層消耗更多金。然而評估成本時須納入產品生命週期需求:一台伺服器背板含 50 個線卡插槽,每槽 10 年內插拔 500 次以上,除了硬金別無經濟可行的方案。
現場因接點磨損導致故障(派員、停機、換件)的成本遠高於硬金溢價。若插拔需求極低(少於 20 次),ENIG 甚至 OSP 即可勝任。決策應基於接點實際機械壽命需求,而非預設規格。
硬金最佳化設計考量
金手指間距、倒角與電鍍區域定義
金手指設計須遵循特定規則以確保可靠插拔與長期性能。指寬與間距須與對接連接器規格完全吻合。常見間距有 1.27 mm(50 mil)、1.0 mm 與 0.8 mm 高密度型。
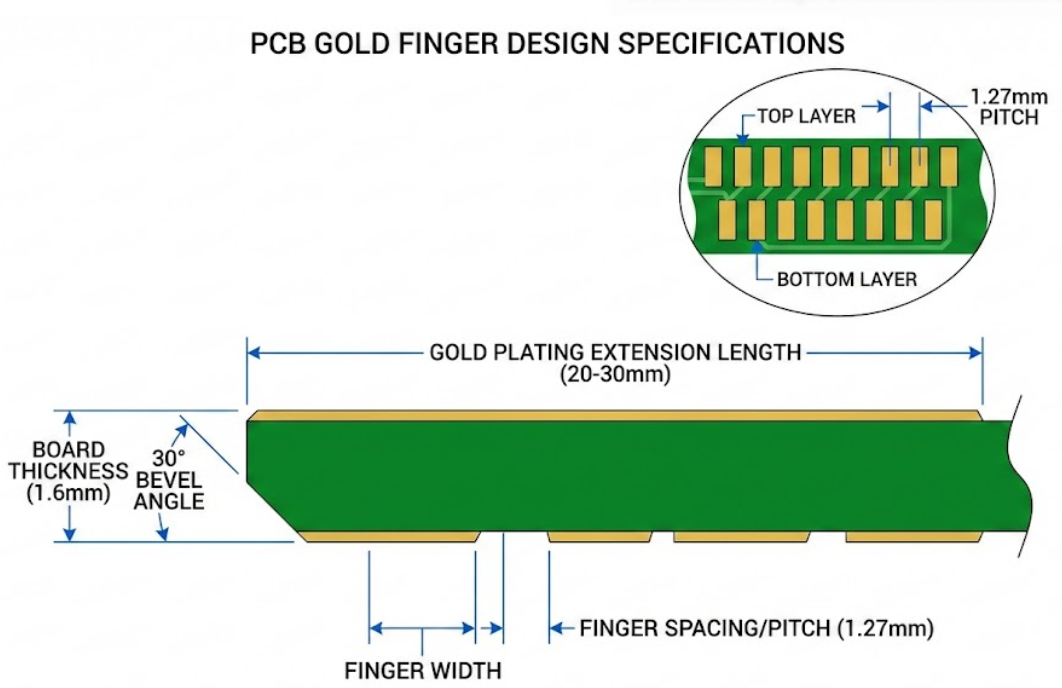
倒角係將板邊以 30–45° 倒角,利於順利插入並降低初始接觸力,避免損傷金面。多數設計指定插入邊 30° 倒角。
電鍍區域定義須謹慎:金層須自板邊延伸足夠長度,以在完全插入後仍保持接觸,但不可無謂延伸,每多一平方毫米皆增加成本。典型金手指自板邊延伸 20–30 mm,視連接器規格而定。
透過厚度控制避免脆裂
硬金專案最需留意的是金層脆裂。厚度超過 2.5 µm 時,內應力可能導致裂紋,尤其在尖角或邊緣。硬化用的鈷或鎳雖提升硬度,卻降低延展性,因此存在磨耗與機械完整性之間的最佳厚度區間。
多數邊緣連接器採用 0.75–1.5 µm 硬金覆於 2.5–5.0 µm 鎳層,可承受數千次插拔,又保有足夠韌性,避免板彎或受熱時裂開。若需超過 1 000 次極端耐用,可將金厚增至 2.0–2.5 µm,但須避開幾何急轉角以減少應力集中。
與整體 PCB 佈局及 DFM 規則整合
硬金區域須在整體佈局中特別規劃:電鍍匯流排須於製程中將所有金手指墊連至共同電鍍軌,這些臨時走線通常與金手指同層,並於電鍍後透過撈洗或 V-Cut 去除,設計時須預留路徑。防焊開窗須精準,僅露出待鍍金區,同時保護鄰近特徵。
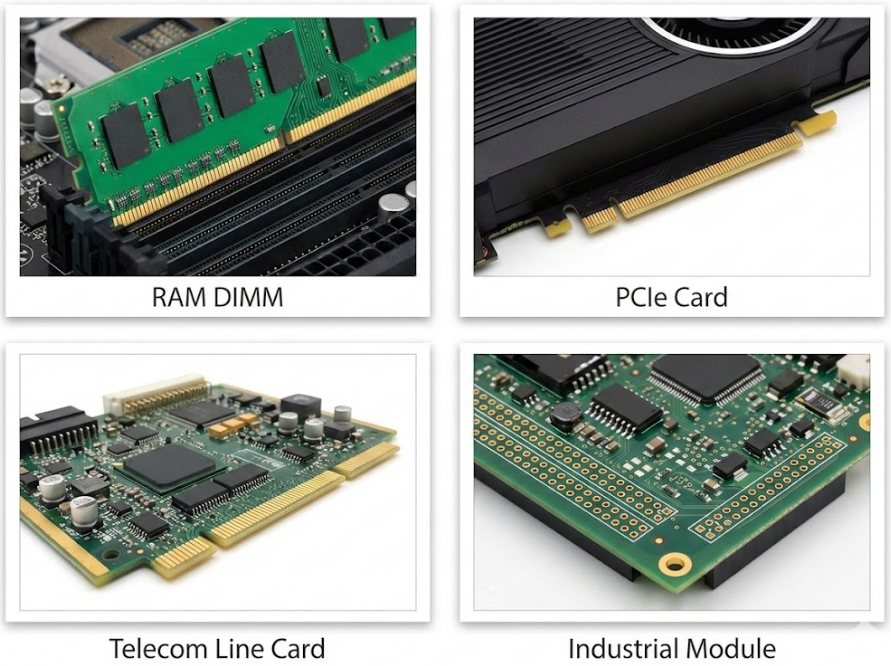
防焊對金手指的對位公差極為關鍵:防焊溢上金手指會造成插入干涉,間隙過大則銅裸露易氧化。DFM 審查應確認金手指尺寸符合目標連接器規格、倒角尺寸正確、電鍍匯流排可實現,且鍍與不鍍區的過渡區管理得當。
硬金表面處理的精密製造
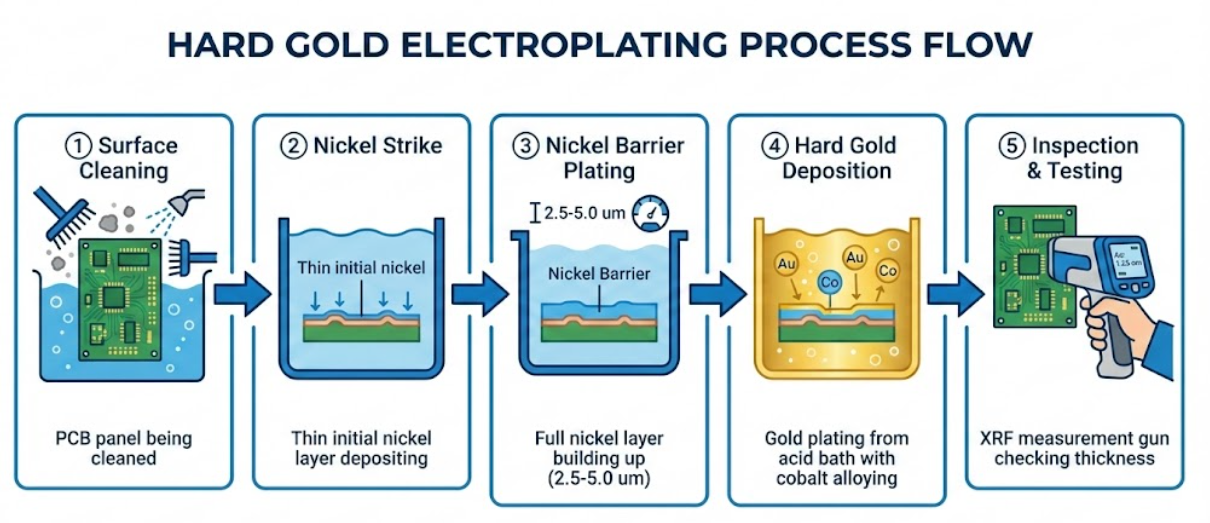
電鍍鎳屏障與金層沉積
整個硬金流程始於板內其他製程完成後。先清潔銅面,再電鍍鎳打底:先薄鎳觸擊層,再鍍主鎳屏障(約 2.5–5.0 µm 氨基磺酸鎳),提供硬基底並防止擴散。
鎳層完成後,換至含金鈷或金鎳的酸性金槽。透過控制電流密度、槽溫與攪拌,使金層硬度與結晶粒度達標。使用庫侖法量測厚度,確保各處金厚符合規格。
均勻性控制與後續清洗
要讓整片金手指厚度一致並不容易。邊角因電流集中易形成“狗骨”效應,導致局部過厚。為此,電鍍廠使用輔助陽極、電流竊取器與特殊掛架,使電流分布均勻,將厚度差降至最低。
電鍍後,以超音波清洗與去離子水沖洗,去除殘留化學品與汙染,避免影響接點。再以顯微鏡檢查金面是否有凹坑、結節、汙漬或異物。
嚴格測試附著力、硬度與接觸電阻
硬金須通過多項測試:XRF 驗證金/鎳層厚度在規格上下限內;Knoop 微硬度測試確認金合金硬度達 130–200 HK;膠帶附著力測試(IPCTM650)確保金、鎳與銅彼此附著良好;接觸電阻須低且均勻,方為合格電接觸。所有測試皆在實際生產樣本與測試條上執行,確保每批符合規格。
JLCPCB 打造高品質硬金 PCB 的專業實力
先進電鍍線,厚度與耐久性一致
JLCPCB 的電鍍廠配備專用硬金產線,具精密電流控制、自動厚度監控與最佳化槽液配方,確保每片板金厚與硬度一致,接點性能可靠。

客製金手指規格專家支援
金手指規格因連接器標準與專案需求而異。JLCPCB 工程團隊可協助特殊訂單:超薄金、特定鎳底、選擇性電鍍或特殊倒角,不論是 PCIe 卡邊規格或全新專屬介面,皆可配合。
可靠量產,確保長期接觸性能
JLCPCB 擁有豐富硬金量產經驗,涵蓋消費級到工業背板。每片出貨板皆通過 XRF 厚度檢測與目檢,確保接點在產品生命週期內保持可靠。

常見問題(FAQ)
Q. 硬金與 ENIG 有何不同?
ENIG 以化學法在鎳上沉積薄(0.05–0.1 µm)軟金;硬金以電鍍法在鎳上沉積厚(0.5–2.5 µm)鈷合金金。
Q. 硬金可承受多少次插拔?
正確規格的硬金(0.75–1.5 µm 於 2.5–5.0 µm 鎳上)通常可承受 500–1 000 次以上;更厚金層可再提升。
Q. 同一板能否同時存在硬金與 ENIG?
可以。硬金用於邊緣連接器與接觸區,ENIG 用於焊墊。選擇性電鍍僅在連接電鍍匯流排處長金,因此同一板可同時擁有不同表面處理。
Q. 硬金越厚越好嗎?
非也。過厚(>2.5 µm)硬金可能變脆易裂。最佳厚度取決於預期插拔次數與機械應力環境。
Q. 硬金為何比其他表面處理貴?
成本來自金料本身(貴金屬市價)、厚鍍層(比 ENIG 多 10–50 倍金)與需專用設備及精準控制的電鍍製程。

持續學習
PCB過孔防護工藝:蓋油、塞孔與填充技術解析
過孔蓋油(Via Tenting)是PCB製造中基礎且經濟的過孔防護手段。該工藝透過阻焊漆直接覆蓋過孔及其焊環,將過孔與外部環境隔離,是常規設計中最常用的基礎防護方案。 一、過孔蓋油的核心作用與工藝短板 1. 主要防護作用 抑制焊錫流失:SMT迴流焊過程中,可避免錫膏沿過孔滲透至板面背面,減少焊點空洞、短路等不良問題。 強化絕緣防護:降低元器件裝配時誤觸過孔引發的意外短路風險,提升板面絕緣可靠性。 2. 工藝固有侷限 阻焊漆無法完全填充過孔,孔內會留存空腔。高溫焊接時,孔內殘留水分或氣體受熱膨脹,易導致阻焊層開裂;酸性製程中還可能出現藥水殘留,長期會造成孔壁腐蝕損傷,僅適用於普通工況場景。 圖1. Via Tenting的結構示意圖 二、過孔塞孔與填充:定義差異及工藝層級 工程應用中,Via Plugging(過孔塞孔)與Via Filling(過孔填充)常被混用,但依據IPC-4761工業標準,二者工藝要求存在明確層級差異。 過孔塞孔:多採用阻焊油墨或基礎樹脂封堵孔徑,核心目的是阻擋錫膏滲入,無需保證孔內完全填充,也不強制要求表面平整。 過孔填充:屬於高精度工藝,多用於高端PCB設計。採用專用樹......
物理語義的最後一道工序:PCB 絲印實戰設計與故障規避
高度自動化的SMT生產線上,印刷電路板(PCB)絲網印刷層通常被視為非功能性層。然而從失效分析(FA)的角度來看,絲網印刷層的設計缺陷會導致一些關鍵且隱藏的問題,例如焊點不良、反極性組裝以及自動光學檢測(AOI)系統中頻繁出現誤報。 身為設計工程師,PCB絲網印刷層上的每一行都是維修人員和機器人的戰術地圖。 一、 防止焊盤污染:網版印刷中的幾何限制 工程師最常犯的錯誤之一是將印刷電路板元件的標記點離焊盤邊緣太近。在生產過程中,網版印刷油墨具有特定的流變特性。當它們滲入焊盤區域時,可能會引發連鎖反應,例如: 1.潤濕不良:油墨與焊錫不相容,阻礙金屬間化合物(IMC)的形成。 2.焊點脆化:即便強行焊接,夾雜在焊點中的碳化油墨會成為應力集中點。 DFM 實務規範: 絲印到焊盤間距 (Clearance):應嚴格保持在>=6 mil(0.15mm)。 絲印到外形線距離:必須>=10 mil(0.25mm),防止分板時油墨崩裂。 二、 光學對比度:PCB Silkscreen Color 與 AOI 辨識策略 選擇pcb silkscreen color絕非視覺喜好,而是一場關於訊噪比的博弈。現代 AOI......
比較 PCB 的 HASL 與 ENIG 表面處理
為印刷電路板(PCB)選擇合適的表面處理方式,對於確保其效能、可靠性與使用壽命至關重要。其中,熱風整平(HASL)與化學鎳金(ENIG)是最常用的兩種表面處理。這兩種表面處理各有優缺點,適用於不同的應用情境。本文將比較 HASL 與 ENIG,協助您判斷哪種處理最適合您的 PCB 專案。 什麼是 HASL? 熱風整平(Hot Air Solder Leveling, HASL) 是一種表面處理技術,將 PCB 浸入熔融焊料槽中,再以熱風刀吹除多餘焊料,使銅焊墊上留下均勻的焊料層。HASL 可使用含鉛或無鉛焊料,後者更環保且符合 RoHS(有害物質限用)標準。 HASL 表面處理 HASL 的優點 1. 成本低廉:HASL 是最經濟的表面處理之一,特別適合成本敏感的專案。 2. 可焊性佳:焊料層提供優異的可焊性,有助於組裝時形成可靠焊點。 3. 供應普及:HASL 製程成熟,大多數 PCB 製造商均可提供。 HASL 的缺點 1. 熱應力:高溫製程可能產生熱應力,導致薄板翹曲或分層。 2. 表面不平:HASL 表面可能高低不平,對細間距元件與表面貼裝技術(SMT)造成困難。 3. 氧化問題:焊料層長......
為您的 PCB 選擇合適的表面處理:HASL、ENIG、OSP、沉積錫與沉積銀概述
印刷電路板(PCB)是製造電子設備(從智慧型手機到工業機械)的關鍵元件。PCB 由基材、銅導線、防焊層及表面處理組成。表面處理是在銅導線上施加的一層薄金屬,作為保護塗層並協助電子元件焊接。 選擇合適的表面處理對 PCB 的功能與可靠性至關重要。表面處理會影響 PCB 的耐腐蝕性、可焊性及電氣性能等。此外,不同表面處理各有優缺點,因此了解每種特性十分重要。 PCB 表面處理類型 HASL(熱風整平) HASL 是 PCB 製造中最常用的表面處理之一。其流程是將銅導線浸入熔融焊料,再以熱風整平,形成光滑均勻的表面,易於焊接。 優點: 成本低 易於施作 適合通孔元件 易於重工 缺點: 表面不平整 細間距元件效果差 HASL 不符合 RoHS 應用: 消費性電子 工業機械 汽車電子 ENIG(化鎳浸金) ENIG 是在裸露銅導線上先沉積一層薄鎳,再覆上一層金的表面處理。鎳層可防止銅擴散至金層,金層則提供優異的可焊性與抗腐蝕性。 優點: 可焊性極佳 適合細間距元件 電氣性能良好 符合 RoHS 缺點: 成本高 重工性有限 不適合高溫應用 應用: 航太 醫療設備 通訊 OSP(有機保焊劑) OSP 是在銅導線......
現代電子製造的熱力學核心:回流焊工藝
在電子產品邁向極度微型化與高頻化的今天,PCB焊接工藝的穩定性直接決定了終端產品的壽命與可靠性。作為表面貼裝技術SMT中最為關鍵的環節,回流焊不僅僅是簡單的加熱與冷卻,而是一場涉及流體力學、冶金反應與精準熱控的複雜工程。 一、焊接的基石:焊膏的科學 一切完美的焊接都始於PCB焊膏的正確應用。焊膏並非單一物質,而是一種由懸浮在觸變性助焊劑中的球形合金粉末構成的非牛頓流體。 1. 合金成分與顆粒度:現代無鉛工藝多採用 SAC305(錫銀銅)合金。顆粒度(Type3至Type6)的選擇取決於鋼網的開孔尺寸。01005 甚至 008004 元件,必須使用更細的Type 5/6焊膏以防止印刷缺失。 2. 助焊劑的多重任務:在SMT回流過程中,助焊劑需在特定溫度下激活,清除焊接表面的氧化層,降低熔融金屬的表面張力,並在冷卻前防止二次氧化。 3. 印刷質量(SPI):約60%-70% 的焊接缺陷(如橋接或少錫)追根溯源都來自印刷階段。控制焊膏的黏度與印刷壓力是確保後續回流成功的前置條件。 二、回流焊爐的構造與熱傳遞機制 高性能的回流焊爐是實現高良率的物理保障。現代設備通常包含8到12個獨立溫區,透過強制對流將熱......
PCB Solder Mask 技術規格與 DFM 設計策略
印製電路板PCB的製造過程中,覆蓋在銅線上的聚合物塗層(即阻焊層)發揮著至關重要的作用。阻焊層承擔著多項重要職能:防止在組裝過程中發生焊料橋接,抵禦由環境濕度引起的氧化侵蝕,確保電路的電氣絕緣性能。 阻焊層也被稱為阻焊劑。隨著元件整合密度的不斷提升,阻焊層的精度與穩定性已演變為關鍵的物理限制因素,並最終影响硬體設備的長期可靠性。 一、物理與化學特性:LPI 墨水的技術演進 阻焊層製作製程中通常會採用液態光成像(LPI)油墨。這構成了熱固化與光聚合特性相結合的複合體系,其成分通常包括環氧樹脂、光引發劑和顏料。 塗佈與曝光:LPI 油墨會被覆蓋基板的整個表面—通常透過網版印刷或幕塗製程實現—隨後基板將接受精確的紫外線(UV)曝光處理。未受光照射的區域隨後會被顯影液去除,從而在阻焊層中形成所需的開窗結構。 介電常數與厚度:阻焊層厚度通常控制在20至40微米內。處理高頻訊號時,阻焊層的介電常數會影響微帶線的特性阻抗。因此在射頻(RF)電路設計中,對阻焊層塗覆均勻性進行嚴格管控顯得至關重要。 二、顏色背後的科學:綠色阻焊層仍是首選 目前的阻焊層顏色選項極其豐富(黑、白、藍、紅、紫色),但綠色阻焊層在高性能電......