什麼是 BGA 空洞?成因、IPC 規範與解決方案
1 分鐘
- 什麼是 BGA 空洞?它如何在焊點中形成?
- PCB 組裝中 BGA 空洞的常見根本原因
- BGA 空洞的類型與分類
- IPC 標準對 BGA 空洞的可接受水準
- 如何減少並預防 BGA 空洞:經證實的解決方案
- JLCPCB 如何在量產中控管 BGA 空洞
- X-Ray 檢測(AXI)於 BGA 空洞偵測與分析
- BGA 空洞常見問題
- 結論
在 SMT(表面貼裝技術)高風險的世界裡,BGA(球柵陣列)是現代高密度電子的關鍵元件,但它也帶來了複雜的挑戰:BGA 空洞。分析固然重要,但任何 PCB 設計師或製造商的最終目標都是預防。
與可見焊點不同,BGA 連接隱藏於內部。空洞——即固化焊料中滯留的氣泡——會削弱導熱與機械完整性。
在 JLCPCB,我們透過嚴格遵循 IPC 標準、先進的 DFM 檢查與精準的回流曲線,優先降低空洞率。本指南聚焦於可操作的策略,以實現近零空洞。
什麼是 BGA 空洞?它如何在焊點中形成?
BGA 空洞本質上是焊點內部的空腔。當助焊劑或電路板濕氣中的揮發物在回流過程中轉化為氣體,卻在焊料固化前無法逸出時,就會形成空洞。
焊膏熔化時,助焊劑載體在清潔金屬表面時產生氣體。理想情況下,這些氣泡因浮力上升至表面並消散。然而,若熔融焊料的表面張力過高,或冷卻階段過早開始,氣體就會被困住,實際上在金属接點內凍結了一顆氣泡。
技術備註:空洞形成的物理學是浮力(將氣體推出)與黏滯阻力/表面張力(將氣體留住)之間的較量。
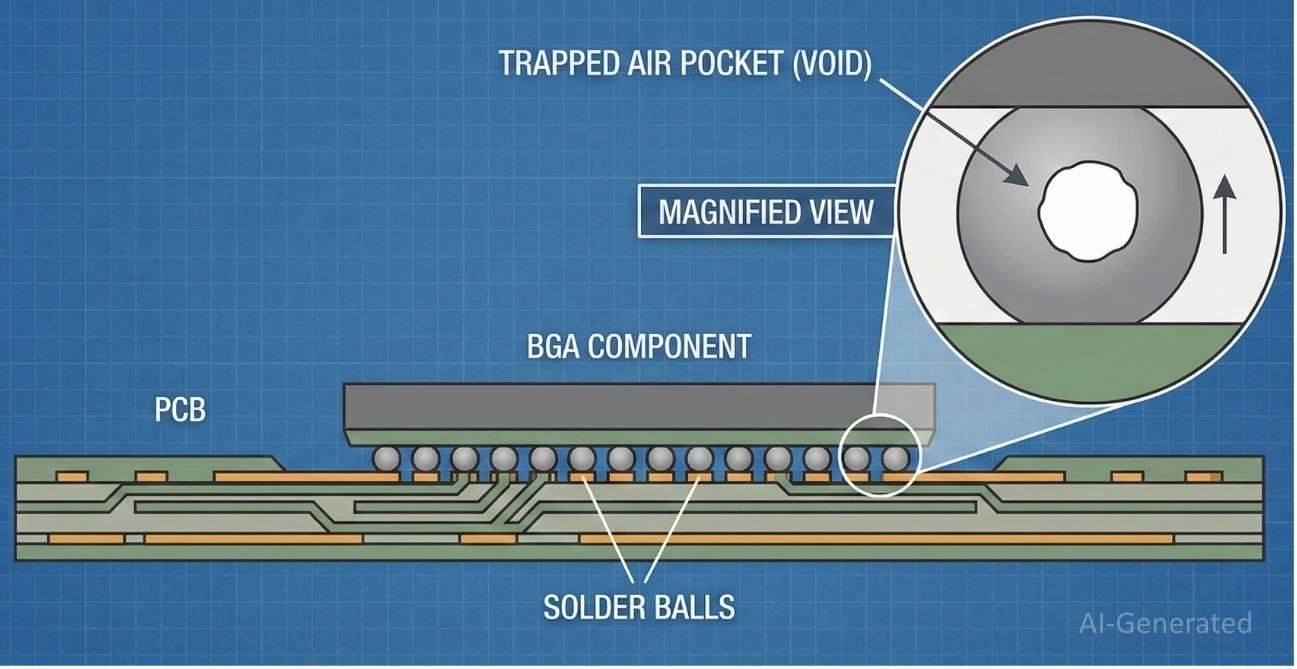
圖: 因 SMT 回流時助焊劑排氣,空洞被困在焊球內。
PCB 組裝中 BGA 空洞的常見根本原因
要減少空洞,首先得了解其來源。約 90% 的空洞問題源自以下四個方面。
原因 1:焊膏化學成分與助焊劑揮發物
所用焊膏類型是主要因素。焊膏由金屬合金球與助焊劑載體混合而成。
● 高揮發物含量:為提高潤濕性而設計的助焊劑常含更多揮發性溶劑。若這些溶劑在回流的「浸潤」階段未能完全揮發,將在「回流」階段劇烈沸騰,形成大空洞。
● 無鉛合金:SAC305 等無鉛合金比傳統 SnPb 焊料表面張力更高,使氣泡更難逸出。
原因 2:回流熱曲線不當
電路板在回流爐內經歷的溫度曲線至關重要。
● 浸潤時間過短:「浸潤區」(通常 150°C 至 190°C)應讓揮發物燒掉。若此階段太短,氣體仍滯留。
● 液相線以上時間(TAL)過短:若焊料保持熔融的時間太短,氣泡無足夠時間升至表面破裂。
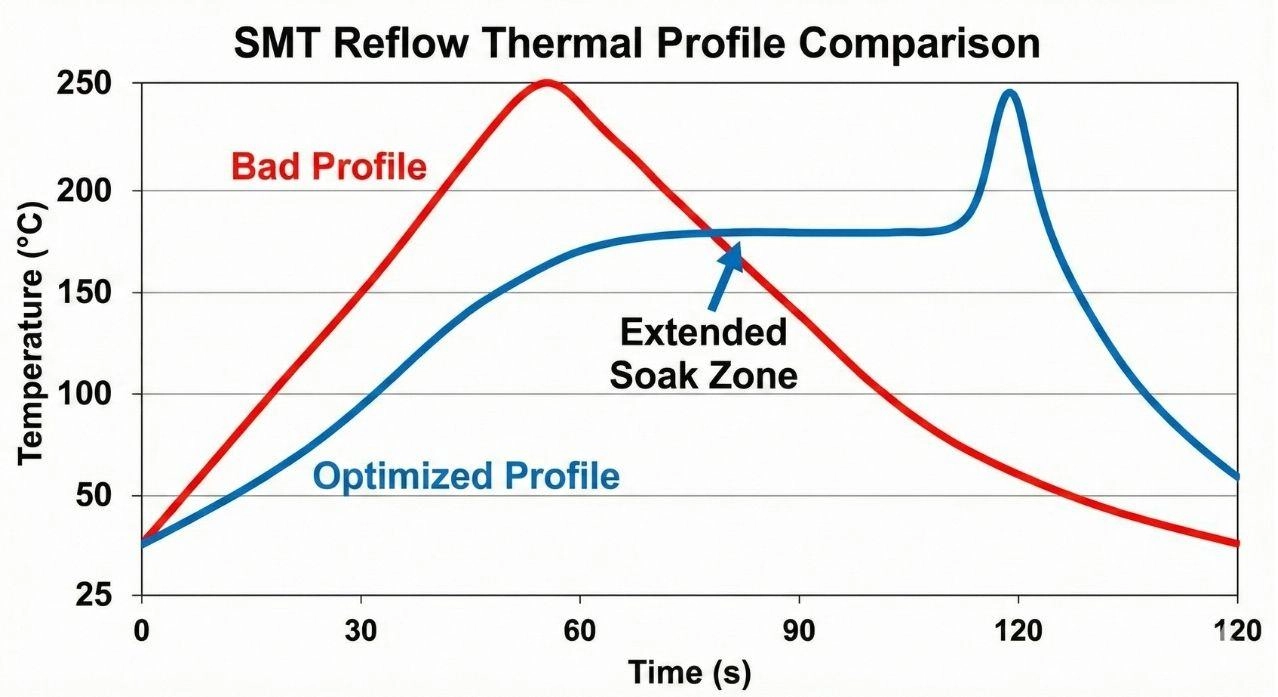
圖:SMT 回流熱曲線顯示延長浸潤區以降低 BGA 空洞。
原因 3:PCB 焊墊設計與焊盤中導通孔缺陷
這是 JLCPCB 收到的 Gerber 檔案中常見的問題。
● 開放焊盤中導通孔:若導通孔直接置於 BGA 焊墊而未填塞或覆蓋,空氣會像煙囪一樣從板底經導通孔上升,衝入熔融焊球,形成巨大空洞。
查看我們的「焊盤中導通孔」能力,了解我們如何為高密度設計處理填孔。
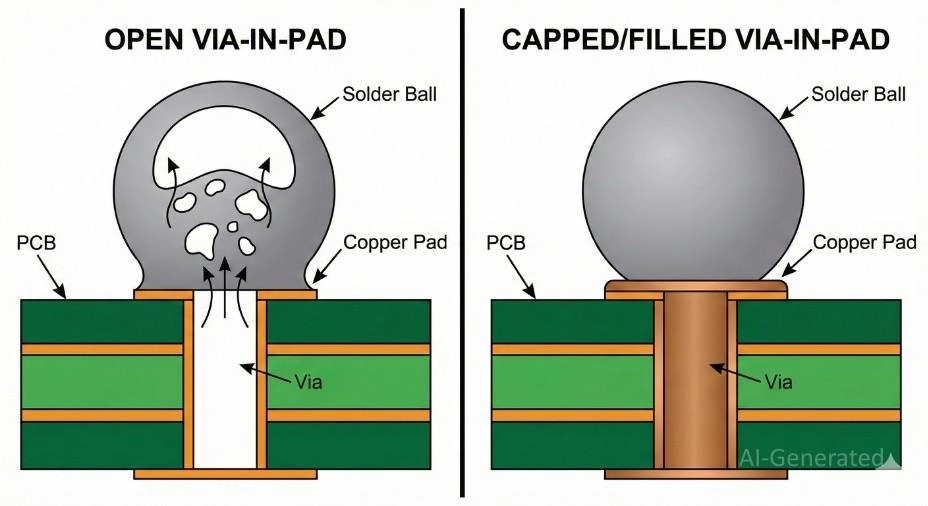
圖:展示開放焊盤中導通孔設計如何造成巨大 BGA 空洞,相較於填孔技術。
原因 4:鋼板開孔與印刷問題
若 SMT 鋼板沉積過多焊膏,過量的助焊劑體積會產生無法逸出的氣體。反之,1:1 圓形開孔常在印刷時於角落困住空氣。
BGA 空洞的類型與分類
並非所有空洞都相同。辨識空洞「種類」有助於排查根本原因。
1. 宏觀空洞(製程空洞):最常見,由助焊劑氣體被困造成,通常隨機漂浮於焊球上半部。
2. 平面微空洞:位於焊料與焊墊介面的小而危險的空洞,常由表面處理問題(如 ENIG 黑墊)引起,可能導致災難性「枕頭效應」失效。
3. 收縮空洞:看似鋸齒裂紋而非光滑氣泡,在冷卻階段形成,當焊球外部先硬化,內部金屬收縮產生真空腔。
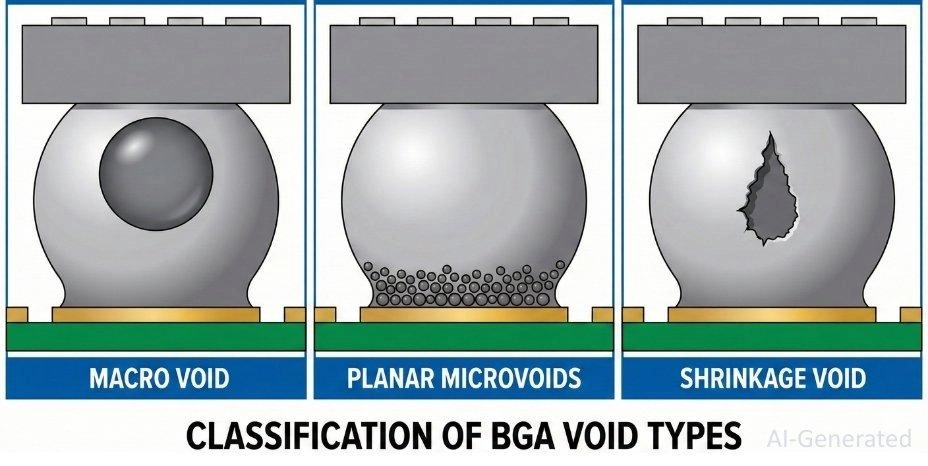
圖:BGA 空洞類型:宏觀空洞、平面微空洞與收縮空洞。
IPC 標準對 BGA 空洞的可接受水準
重要的是並非所有空洞都是失效。實際上,小空洞有時可阻止裂紋擴展。然而,可靠性取決於空洞的大小與位置。
業界標準為IPC-7095(BGA 設計與組裝製程實施)。
| 等級 | 產品類型 | 可接受空洞標準(面積 %) |
|---|---|---|
| Class 1 | 一般消費電子 | < 60% 空洞面積直徑 |
| Class 2 | 專用服務電子 | < 25% 累積空洞面積 |
| Class 3 | 高可靠性(醫療/航太) | < 25% 累積空洞面積(更嚴格製程控管) |
如何減少並預防 BGA 空洞:經證實的解決方案
若您正在設計可製造性(DFM)或設定製程,以下方法可將空洞控制在 25% 以下。
1. 最佳化回流曲線
對 BGA 組裝而言,「斜坡-尖峰」曲線常遜於「斜坡-浸潤-尖峰」曲線。
● 延長浸潤:增加浸潤時間(60–90 秒)讓助焊劑溶劑在合金熔化前排氣。
● 控制冷卻:受控冷卻速率可防止收縮空洞。
2. 鋼板設計最佳化
BGA 焊墊別再用標準圓形開孔,可考慮「窗格」或「本壘板」設計。
● 窗格:將大開孔分割成四個小方格,可減少總焊膏量並提供氣體逸出通道。
向 JLCPCB 訂購高精度電拋光鋼板,確保完美脫模。

圖:BGA 焊墊的鋼板開孔設計,包括本壘板與窗格,以利氣體逸出並降低空洞。
3. 選用低空洞焊膏
改用專為「低空洞」配方的焊膏可立即見效。這類焊膏常使用能在更低溫度排氣的特定活性劑。
除標準製程設定外,以下實用技巧供 PCB 設計師與組裝技術員在板子上線前降低空洞風險。
4. 選用 NSMD(非防焊限定)焊墊提升潤濕性
可行情況下使用NSMD 焊墊。NSMD 設計的防焊開口大於銅墊,周圍留有細縫,利於氣體逸出,相較於 SMD(防焊限定)焊墊的防焊覆蓋銅面更佳。NSMD 焊墊亦能提供更佳的焊點應力緩解。
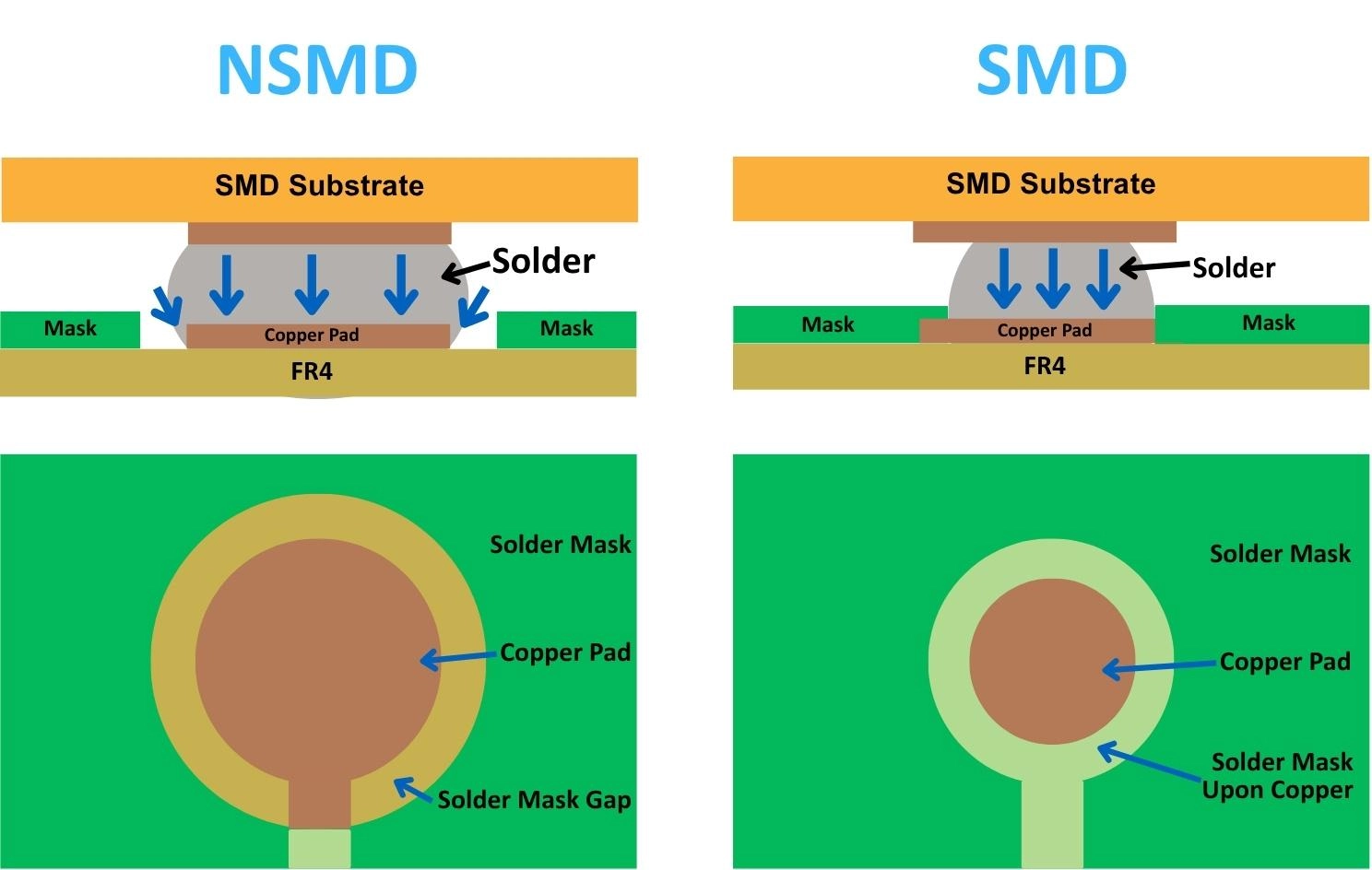
圖:SMD 與 NSMD 焊接差異
5. 控管濕敏等級(MSL)與元件烘烤
BGA 封裝或 PCB 基材內的濕氣在回流時變成蒸汽,助長空洞。
● 實用技巧:若 BGA 元件已暴露於濕氣,組裝前務必依 J-STD-033 標準烘烤。JLCPCB 遵循嚴格儲存協議,確保上線前元件乾燥。
6. 焊盤中導通孔採用 POFV(電鍍填孔)技術
若設計需將導通孔直接置於 BGA 球下(常見於 0.4 mm 間距零件),必須使用 POFV 技術。
● 風險:標準防焊覆蓋不足以阻氣,空氣會衝破防焊層。
● 解決方案:JLCPCB 的 POFV 製程以環氧樹脂填孔並電鍍銅覆蓋,形成平坦、氣密的表面,消除導通孔引起的空洞。

圖:JLCPCB 焊盤中導通孔與覆蓋及塞孔導通孔的比較
7. 正確處理焊膏
開罐前讓焊膏自然回溫至室溫。開冷罐會引入凝結水,成為空洞主要來源。
JLCPCB 如何在量產中控管 BGA 空洞
處理 BGA 需要先進設備與經驗工程師的協同。
● 精度:我們支援細間距 BGA 至0.35 mm。
● 驗證:X-Ray 檢驗是標準流程,非昂貴附加。
● 效率:智慧工廠依您的特定 BOM 與板厚最佳化回流曲線。
了解更多:JLCPCB PCB 組裝能力
準備製造高可靠性 PCB?
上傳您的 Gerber 檔案 至 JLCPCB,立即取得報價與專業 SMT 組裝。

X-Ray 檢測(AXI)於 BGA 空洞偵測與分析
由於 BGA 接點夾在元件與 PCB 之間,目檢(AOI)無用,肉眼無法看見空洞。
因此自動 X-Ray 檢測(AXI)是可靠 BGA 組裝的必備手段。X-Ray 可穿透矽與 FR4 材料,卻被鉛錫合金阻擋。在 X-Ray 影像中,焊球呈深色,空洞則顯示為球內較亮的斑點。
JLCPCB 對所有含 BGA 的 PCBA 訂單採用高解析X-Ray 檢測。品保工程師依 IPC 標準量測空洞百分比,若超出安全閾值,板子將在出貨前被標記重工或拒收。
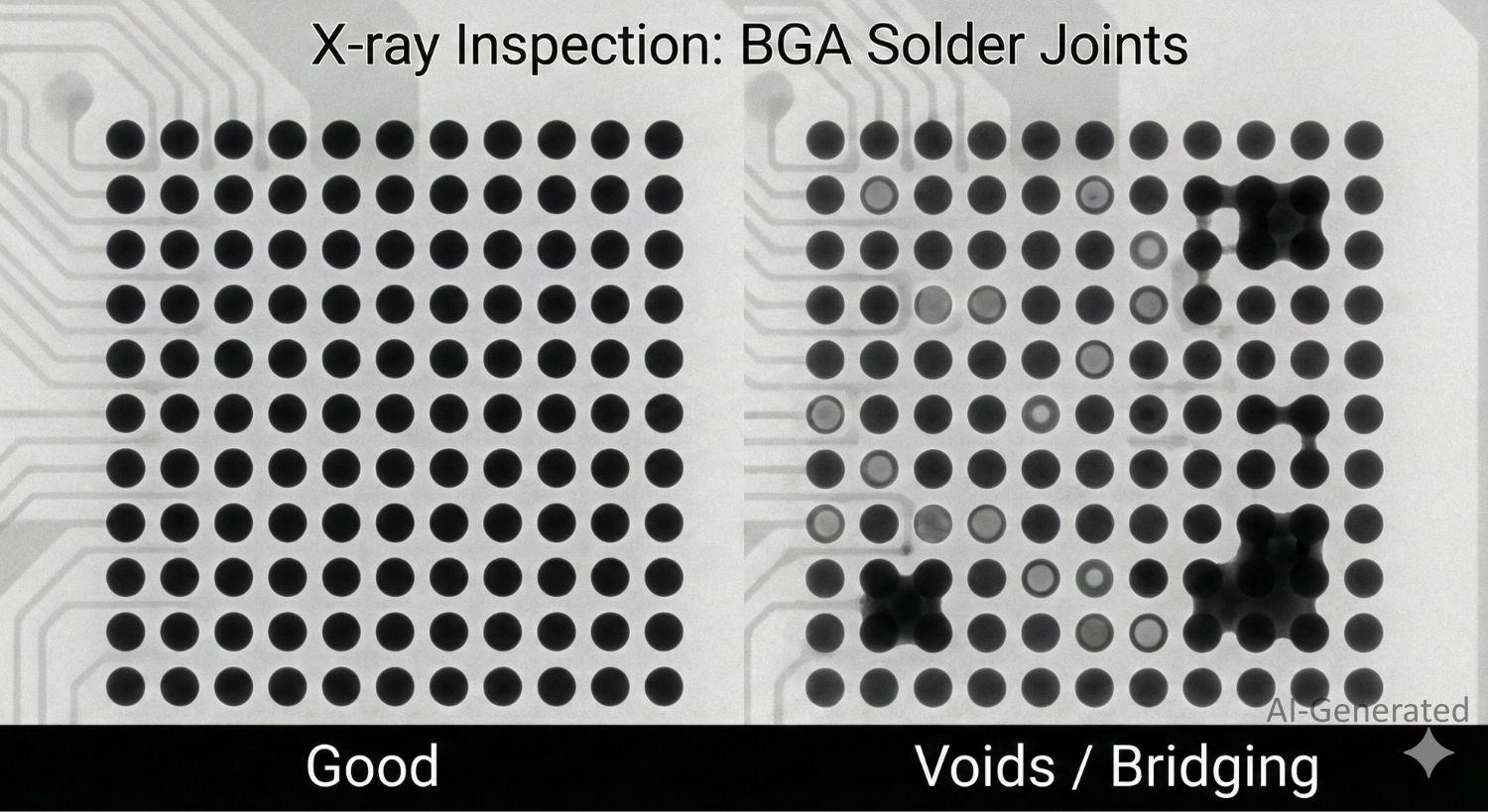
圖:2D X-Ray 檢測影像顯示球柵陣列組裝中的 BGA 空洞偵測。
BGA 空洞常見問題
Q1. 有可能達到 0% BGA 空洞嗎?
實際製造環境中,整顆 BGA 達到 0% 空洞極為困難,因助焊劑排氣物理限制。即便 IPC Class 3 高可靠標準也允許部分空洞(最多 25% 面積)。目標非完全消除,而是控制空洞大小與位置,確保不影響機械或電性完整性。
Q2. 烘烤元件能消除 BGA 空洞嗎?
組裝前烘烤元件(MSL 控管)可去除封裝內濕氣,防止「爆米花」裂紋。雖可消除濕氣導致的蒸汽泡,卻無法阻止焊膏助焊劑排氣造成的空洞。需同時做好元件儲存與正確回流曲線。
Q3. 組裝後能修復 BGA 空洞嗎?
可以,但屬侵入性製程。若 X-Ray 偵測過量空洞,需用熱風重工台將整顆 BGA 拆下,清理焊墊,再重新焊接新元件。多次重工會對 PCB 焊墊造成熱應力,因此首選 JLCPCB 的受控製程一次到位。
Q4. 為何無鉛(RoHS)製程更易空洞?
無鉛焊料合金(如 SAC305)表面張力更高,且需更高回流溫度。更高表面張力使氣泡難脫離熔融金屬而被困。此外,更高熱量會使助焊劑更劇烈揮發。
Q5. PCB 表面處理如何影響空洞?
焊墊的平整度與氧化層級有關。ENIG(化鎳浸金)因平整度高,一般為 BGA 首選。但若金鎳介面劣化(黑墊),會造成平面微空洞。HASL(熱風整平)平整度較差,可能導致焊膏印刷不均,間接造成空洞。
Q6:BGA 空洞多少算過量?
對大多數應用,BGA 空洞應控制在焊點面積的25% 以下,符合 IPC 業界標準。
Q7:為何現場 BGA 重球常失敗?
現場 BGA 重球常因一般維修店缺乏工廠的精準熱曲線與 X-Ray 檢測而失敗。無法均勻加熱會使電路板翹曲,導致數百顆微焊球無法一致接觸。
此外,滯留濕氣會在回流時使晶片內部龜裂(爆米花效應)。最終,這些「盲」維修無法保證長期可靠所需的次微米對準。
結論
BGA 空洞預防需結合設計(DFM)、製程(曲線)與材料(焊膏)的整體方法。透過實施這些策略——最佳化回流曲線、選擇合適焊膏、採用 POFV 技術並遵循嚴格處理規範——可大幅降低現場失效風險。
不論您正在開發複雜的 IoT 原型或擴大量產,JLCPCB 均以專業技術與嚴格檢測,每次提供無空洞、高可靠的組裝。
持續學習
關於焊錫絲你需要知道的一切
拉丁字 solidare 意為「使堅固」,這就是焊料(solder)一詞的起源。為了連接兩個金屬部件,這種合金因其低熔點而被使用。焊料是一種用於固定物品的材料,基本上我們可以說是將導線和引腳元件連接在一起。焊接 被視為電子領域中將元件組裝到裸板 PCB 上的一項技能。所使用的焊線對焊接專案的成敗有著重大影響。 它由合金組成,主要以錫和鉛為基礎。在 ROHS 法案/無鉛系統下,現今市場上已有無鉛焊料可供選擇。本文討論了在選擇焊線時應考慮的各種因素,不論您是業餘愛好者還是專業人士。 什麼是焊線? 透過熔化這種合金,可以在兩條導線之間形成合適的接點。雖然這並非真正的焊接。我們可以再次加熱以將它們分開。電子元件透過焊料牢固地固定在 PCB 基板上。它就像一種結締組織。它有各種助焊劑類型、直徑和成分,所有這些都針對特定用途進行了最佳化。焊線有多種粗細可供選擇,選擇方式如下: 0.3–0.5 mm: 用於精細間距元件和手工 SMD 焊接。 0.6–0.8 mm: 用於一般用途的焊接應用。 1 mm 及以上: 用於大型連接器,特別是在電力電子領域。 如何選擇完美的焊線: 在消費者可用的眾多焊料類型中,焊線 是最......
無鉛銲料與含鉛銲料:有何不同?
大多數電子設備都使用焊料將元件連接到 PCB 上。焊接的過程是,當焊料熔化時,它會形成一個連接。這個連接可以是在焊盤之間或導線之間。焊接與焊接不同,我們可以透過稍微加熱來重新連接兩個接點。雖然在進行焊接步驟後需要進行固化和冷卻,但如果在冷卻過程中系統受到任何干擾,將會導致乾焊。電子產業中主要使用兩種 焊料: 含鉛焊料 無鉛焊料 焊料的經典成分是錫和鉛。電子產業長期依賴這種組合。由於健康和環境問題日益增加,人們已經大幅轉向遠離含鉛焊料,這些焊料曾經是標準。在本文中,我們將了解為什麼無鉛焊料已經超越了含鉛焊料。我們將介紹成分差異、熔點和法規標準。 什麼是含鉛焊料? 含鉛焊料是一種含有鉛和錫的焊料合金。含鉛焊料通常被稱為 63/37,這是錫和鉛的比例。這意味著它含有 63% 的錫和 37% 的鉛。但我們為什麼要使用含鉛焊料呢?為什麼它們如此受歡迎?答案是因為它們的低熔點約為 185°C。這種焊料曾經是標準的原因有很多: 冷卻和固化: 含鉛焊料比其他金屬選項冷卻得更慢。這降低了接點開裂的可能性,也不會有乾焊等問題。 潤濕接點: 潤濕接點意味著使將要焊接的兩根導線更有效。這意味著給它們額外的黏附力。使用這種......
為您的 PCB 組裝選擇合適的焊膏
選擇焊膏至關重要,我們在挑選時可以遵循一些準則。助焊劑殘留、合金強度、合金柔韌性、空洞控制、潤濕性能以及其他性能指標的差異,都可能產生重大影響。在 PCB 組裝中,焊膏是一種具黏性的導電介質,用於連接兩種金屬;在電子領域,我們可以說是連接兩條導線或兩個元件的引腳。焊膏的選擇可能決定一次無縫且零錯誤的生產,或是導致昂貴的重工或產品問題。簡單的焊膏需求應涵蓋: 品質: 選擇最適合您的設計、材料與加熱方式的焊膏。 產能: 使用能夠實現更快、更有效加熱與印刷的焊料。 成本: 在材料之間取得平衡,以降低整體製造成本。 本完整指南將涵蓋為 PCB 組裝選擇最佳焊膏所需知道的一切,包括焊膏類型、助焊劑成分、粉末粒徑以及重要的產業標準。 什麼是焊膏? 焊膏是由助焊劑與粉末焊料合金混合而成的黏稠物質,可用於 PCB 網版或鋼板印刷。加熱(回焊)時,焊料顆粒熔化,在 PCB 焊墊與元件引腳之間形成堅固且導電的連接。 焊膏的基本組成: 金屬粉末合金(重量占比 92–96%)與助焊劑(重量占比 6–10%)。 以下提供合金與助焊劑類型的詳細清單。由於某些合金含鉛,我們已撰寫一篇關於無鉛與含鉛焊料優缺點的完整文章。 依合金......
電子焊接套件:初學者必備工具指南與使用方法
如果你正準備踏入電子領域,焊接是你必須掌握的基本技能之一。這是一種將電子元件透過焊料(加熱即熔化的金屬合金)固定到印刷電路板(PCB)上的製程。入門時,你需要一套電子焊接工具組。 但它到底包含哪些工具?本指南將帶你全面了解電子焊接工具組的必備工具與高效使用方法。 1. 什麼是電子焊接工具組? 電子焊接工具組是一套讓任何人都能將電子元件焊接到印刷電路板(PCB)上的工具與材料。不論是專業人士、玩家或初學者,都能靠它快速開始製作或維修電子設備。 焊接工具組的主要目的,是讓以下工作變得簡單又經濟: ⦁ 在 PCB 上組裝元件。 ⦁ 修復連接問題。 ⦁ 打造個人專屬的電子專案。 ⦁ 電子焊接工具組裡有什麼? 2. 重要工具: 一般電子焊接工具組通常包含以下關鍵工具: ⦁ 烙鐵:任何焊接作業都少不了烙鐵。這支手持加熱工具能熔化焊料;部分機型還可調溫,適用各種焊接需求。 ⦁ 焊錫:焊錫是連接元件與 PCB 的金屬合金,通常做成線材,有含鉛與無鉛等類型。 ⦁ 吸錫器:初學難免出錯,吸錫器能輕鬆移除焊料,方便修正。 ⦁ 鑷子:處理電阻、電容或 SMD 等小零件時必備。 ⦁ 海綿或銅絲清潔球:保持烙鐵頭乾淨才能焊得......
BGA PCB設計與組裝實戰:從佈局到良率的全流程避坑心得
致力於BGA PCB設計與產線組裝多年,踩過無數坑才摸透核心規律:前期設計只要有瑕疵,後端組裝再怎麼優化調校,良率都根本提不上來,這是靠實際產線數據與返修案例堆出來的結論。 一、焊盤選型:NSMD與SMD怎麼選才實用 BGA焊盤設計只有兩個方向,沒有複雜的理論套路,全看實際應用場景: NSMD(非阻焊定義焊盤):焊盤邊緣不覆蓋阻焊漆,為目前高速數位電路的首選方案。其優勢在於,焊盤尺寸一致性良好,焊接時焊球能包覆焊盤側面,機械連接強度更高,适配高速訊號的穩定性要求。 SMD(阻焊定義焊盤):焊盤邊緣被阻焊漆覆蓋,看似焊盤固定更牢靠,但熱應力會集中在焊盤邊緣,且有效焊接面積更小,基本不會被高速電路採用。 圖1. BGA 封裝與 PCB 焊盤設計剖析圖 二、孔內置盤(Via-in-Pad):微距BGA的必選方案 現在BGA間距(Pitch)越做越小,常見有0.5mm甚至更細的間距,傳統的“狗骨頭(Dog-bone)”式引出佈線根本放不下,孔內置盤成了唯一選擇。 該工藝的核心難點在過孔塞孔與電鍍平整度:塞孔不平整、內部殘留氣體,回流焊時焊球排氣不順,直接會產生大量空洞,後期返修極難處理。 三、BGA焊接:......
電子產品中的助焊劑酸性物質
簡介 助焊酸(Flux acid)在電子製造過程中至關重要,特別是在印刷電路板(PCB)的組裝中。這種基本化學化合物能清潔並為金屬表面做好焊接準備,確保元件與 PCB 之間形成堅固可靠的連接。本文將探討助焊酸在電子領域的價值,包括其種類、用途以及在 PCB 組裝中的最佳使用實踐。 什麼是助焊酸? 在焊接過程中,助焊酸是一種化學劑,用於清潔並去除金屬表面的氧化物,從而改善元件與 PCB 之間的附著力。在電子製造中,焊點的強度至關重要,助焊酸能確保這些焊點不受污染物影響,提供一個乾淨的表面讓焊料附著。該酸有助於溶解可能阻礙焊接過程的氧化物和其他雜質,確保形成堅固可靠的連接。 助焊酸的種類 PCB 製造中使用多種助焊酸,每種都適用於特定的應用和環境。了解這些類型之間的差異對於選擇適合您製程的助焊劑至關重要。 ⦁ 松香型助焊酸 松香型助焊劑源自松脂,是電子製造中最常用的類型之一。對於一般用途的焊接,它在焊接過程中提供出色的清潔和保護作用。然而,焊接後可能需要清潔以去除殘留物。 ⦁ 水溶性助焊酸: 水溶性助焊劑設計用於易於清潔,焊接後可用水沖洗。它具有高活性,能有效去除氧化物,適用於需要強力清潔作用的更具挑......