深入 PCB 結構:層次、疊構與堆疊如何定義現代電路板的性能
1 分鐘
- 構成任何 PCB 結構的核心要素
- 解讀 PCB 層別及其功能
- 掌握 PCB 疊構,取得最佳成果
- PCB 堆疊方式與製造考量
- 結構影響的實體設計因素
- 常見問題(FAQ)
印刷電路板看起來可能只是扁平的綠色矩形,但在表面之下,它們其實是精密的多層結構。隨著裝置日益小型化與複雜化,工程師轉而採用多層板,並精心挑選材料與疊構,以滿足電氣與機械需求。本文將層層拆解,探討基板選擇、疊層結構與堆疊方式如何左右 PCB 性能。我們將從基礎材料談起,一路涵蓋到高密度互連,帶你掌握 PCB 設計的核心要點。文中也會引用業界最佳實務與成本取捨的指導原則,並比較幾種常見且已成業界標準的疊構。
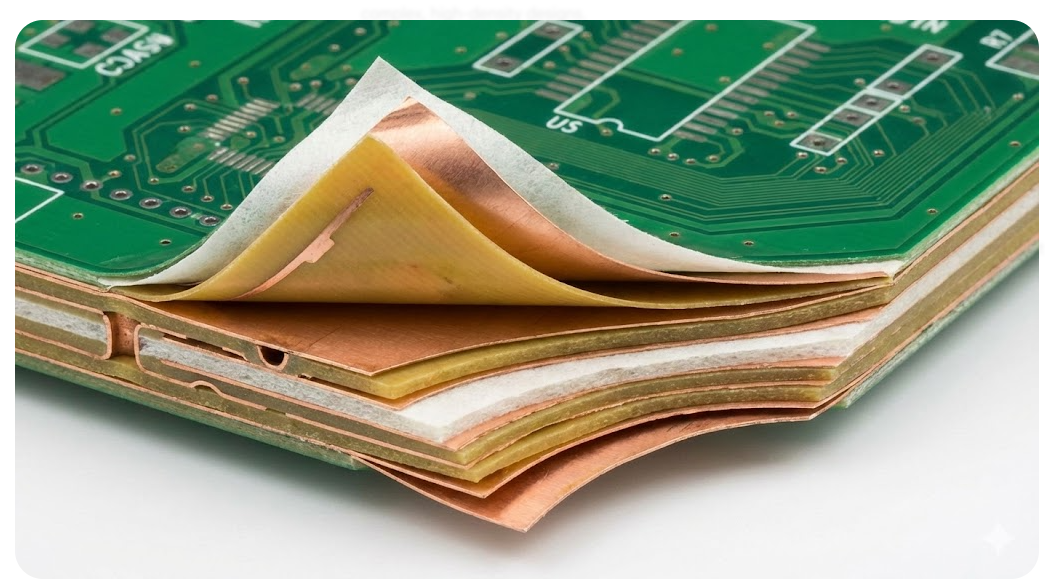
構成任何 PCB 結構的核心要素
基板材料與銅箔基礎
每塊 PCB 都從基板開始,它就像電路板的絕緣骨架。最常見的是 FR-4,價格低廉、機械強度佳,介電常數適中,是萬用的基板選擇。缺點是在射頻頻段損耗較高,因此 RF 與微波板會改用 Rogers 材料,其介電常數穩定且損耗低至約 0.001,性能遠優於 FR-4,但成本約為 5–10 倍。
下一步是在基板上壓合銅箔,銅箔層數決定 PCB 的層數。常見銅厚 0.5 oz 至 2 oz,依載流需求調整;訊號線可用薄銅,電源線則建議用厚銅。
基本疊構中的 Prepreg 與 Core
Core 是雙面已壓合銅的固化基板,剛性高且厚度精準,1.6 mm 標準板可能由一至多片 core 構成。壓合時 prepreg 在高溫高壓下流動,把 core 與外層銅箔黏合。prepreg 最終厚度受壓力與樹脂含量影響,壓合後可能 ±10% 變化。多層板常見 6 層疊構即使用兩片 core,中間與外側夾 prepreg。
Core vs. Prepreg(並排比較): Core 剛性且厚度精準,設計師常把關鍵內層訊號與平面放在 core 上以穩定阻抗;prepreg 擅長填縫,但單獨使用時阻抗精度較低。可把 core 視為骨架,prepreg 視為連接組織。
解讀 PCB 層別及其功能
訊號層 vs. 電源/接地平面
訊號層負責走線與焊墊;電源與接地平面則作為穩定電壓參考與供電網路。多層板通常把內層專門留給連續銅平面,接地平面提供低阻抗迴路並兼 EMI 屏蔽,電源平面則分佈 +3.3 V 或 +5 V。兩者相鄰時形成平行板電容,有助於去雜訊。
將電源與接地緊鄰放置(平面配對)可降低電源雜訊與迴路電感,並抑制地彈與瞬變。這也是為何 IC 電源腳旁要放旁路電容,形成最小迴路。
層數對設計複雜度的影響
層數翻倍約可讓佈線容量翻倍,同時也提高成本與製程難度。2 層板最便宜,但網線一多就擁擠;4 層板常見疊法:
- 訊號
- 接地
- 電源
- 訊號
相較 2 層板,4 層板提供更佳去耦與阻抗控制,成本約增 30–40%。6 層板再增兩層,常見疊法:
- Top(訊號)
- GND
- 訊號
- 訊號
- PWR
- Bottom(訊號)
或
- Top
- GND
- 訊號
- PWR
- GND
- Bottom
層數越高,越能控制走線密度與電源分配,但成本也越高;若成本優先,應盡量減少層數。
多層板的內層與外層差異
外層負責表面貼裝元件與連接器,佈線密度高;內層無法放置表面元件,通常作為走線或連續平面。外層走線為微帶線(一面銅一面空氣),內層為帶狀線(夾在介質中),電容較大、屏蔽較好,阻抗較低。高速差動對常放內層,上下緊鄰參考平面以降低輻射。JLCPCB 建議多層板將接地與電源平面放內層以兼作屏蔽,外層則處理高壓或 I/O。
掌握 PCB 疊構,取得最佳成果
標準疊構範例(2 層至 8 層)
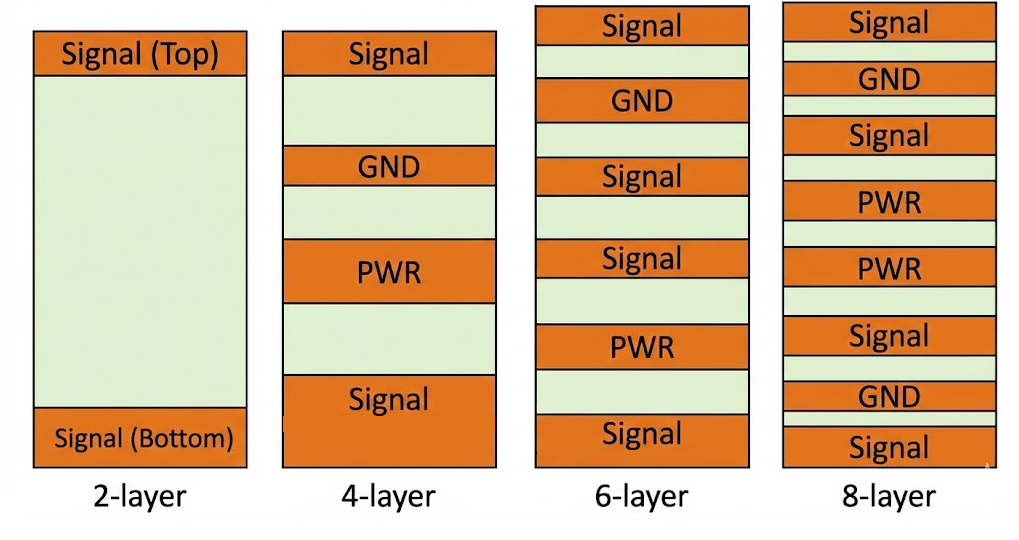
- 2 層 PCB:無內層平面,上下皆為訊號層,常把底層鋪銅當接地,成本低但走線受限。
- 4 層 PCB:Top/Bottom 走線,內兩層為完整平面(GND+PWR),例如 L1=訊號, L2=GND, L3=VCC, L4=訊號,提供良好去耦與阻抗控制,性價比高。
- 6 層 PCB:Top(訊號)–GND–訊號–訊號–PWR–Bottom(訊號),或 Top–GND–訊號–PWR–GND–Bottom,後者雜訊免疫力更佳。
- 8 層 PCB:範例:Top(訊號)–GND–訊號–PWR–PWR–訊號–GND–Bottom(訊號),提供兩組平面配對與四個訊號層,EMI 抑制最佳,但板更厚、成本更高。
疊構對稱與平衡法則
黃金法則:疊構必須上下對稱,避免翹曲。銅厚與層序應以板中心鏡像,例如 6 層板 L1=L6、L2=L5、L3=L4。銅分佈不均會在加熱時造成彎翹。
阻抗控制與訊號完整性
阻抗控制指將走線設計成特定阻抗(常見 50 Ω 單端或 90 Ω 差動)。疊構直接決定線寬與間距,換 prepreg 或移動參考平面都會改阻抗。設計師會用計算器或場求解器調整參數,確保阻抗達標。
良好疊構有助訊號完整性:高速訊號需緊鄰參考平面,JLCPCB 的 HDI 指南建議「訊號下要有地,電源再往上」,形成帶狀線以降低輻射與串音。
PCB 堆疊方式與製造考量
高密度互連(HDI)的順序堆疊
當需要極高密度與大量盲埋孔時,採用順序層壓:先壓合部分層次並鑽孔電鍍,再疊上新的 prepreg 與銅箔進行第二次層壓,如此可做出僅連相鄰層的微盲孔。
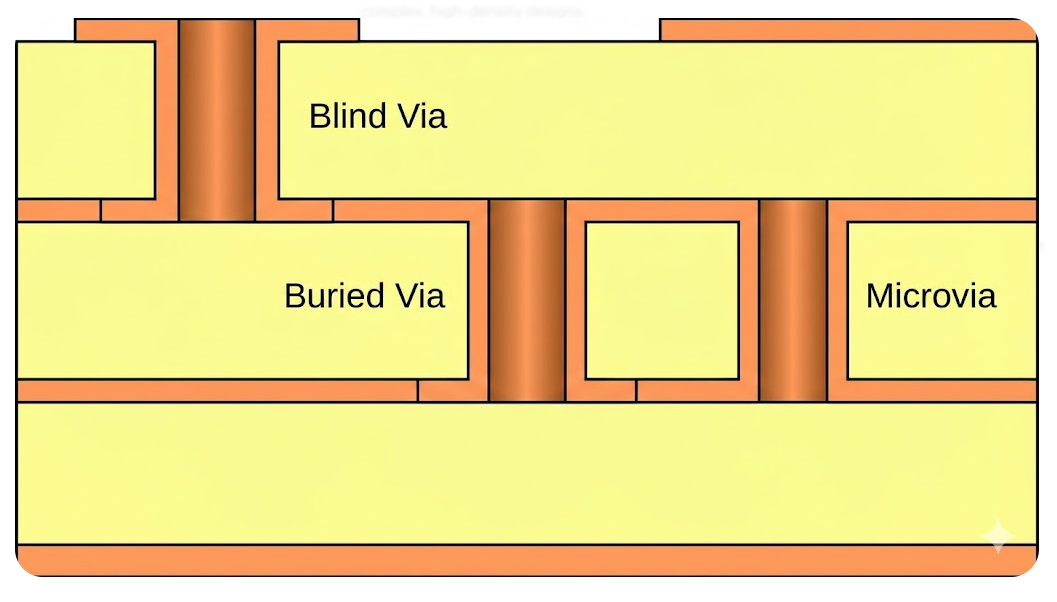
例如 12 層 HDI 可先壓 4 層做埋孔,再疊 4 層做埋孔,最後再疊 4 層並鑽盲孔,逐步完成。
Foil Build 與 Cap Build 比較
PCB 製造商主要採兩種疊板方式:foil build(外層用銅箔)與 cap build(外層用 core)。foil build 最常見,成本與彈性兼顧;cap build 外層為厚 core,常用於微波或 RF 板,以獲得極高尺寸穩定性。
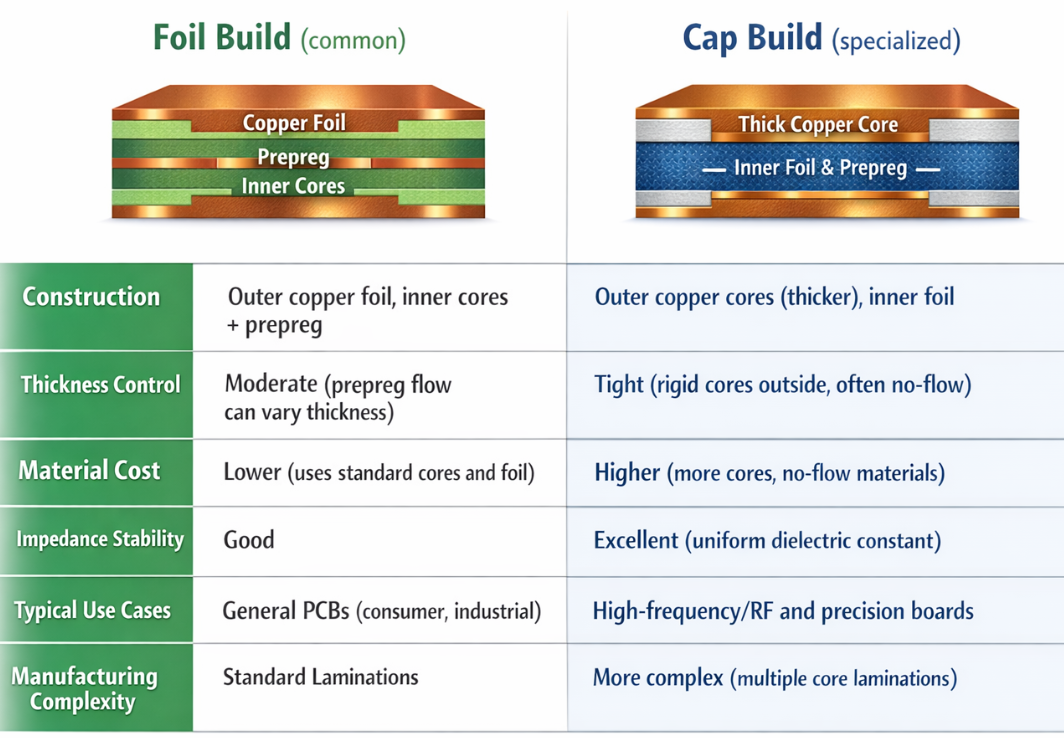
總結:foil build 是主流,cap build 僅在性能關鍵時採用;兩者混用則成 hybrid build,需與板廠密切合作選材。
Hybrid 與 Rigid-Flex 結構變化
除全硬板外,設計師有時需 hybrid 或 rigid-flex 結構。rigid-flex 是將硬板區與 polyimide 軟板區壓合在一起,軟板區銅薄(≤1 oz),用無流動 prepreg 防止樹脂溢入彎折區。熱源元件通常擺在硬板區,以便利用熱孔或平面散熱。
結構影響的實體設計因素
熱管理與機械強度
更多銅與層數可橫向擴散熱量,內層平面如同大型散熱片;但剛性提高後,溫差應力也增大,因此對稱疊構至關重要。FR-4 與銅的熱膨脹係數不同,若失衡易導致翹曲或分層,rigid-flex 需用低 CTE 材料與無流動 prepreg 緩解。

成本、尺寸與可製造性取捨
層數越多成本越高,JLCPCB 分析指出 4→6 層或 6→8 層每步約漲 30–40%。厚銅、特殊材料、微盲孔都會加價。但高層數可縮小板面積,節省的 PCB 面積有時能抵消單價上升。JLCPCB 的免費 DFM 可在設計階段掃描 Gerber,提示線寬、間距、缺平面或散熱不足等常見問題。

常見問題(FAQ)
Q:什麼是 PCB 疊構?
疊構是銅層與介電層的順序安排,決定層數與每層用途。
Q:如何決定層數?
依佈線密度、訊號完整性與預算而定。簡單設計 2 層即可,高速或多腳位晶片通常需 4 層以上,以獲得專用平面與額外走線層。
Q:電源與接地平面的作用?
提供低電感迴路、EMI 屏蔽,並與相鄰平面形成電容,有助於去雜訊。
Q:JLCPCB 能協助驗證疊構嗎?
可以!JLCPCB 提供疊構模板、阻抗計算器,以及免費 JLCDFM 工具自動檢查設計。
持續學習
熱傳導的物理本質:鋁基板與高功率電子散熱技術探討
在電力電子及高亮度照明領域,熱量管理是提升性能的關鍵挑戰。隨著設備功率密度的提升,傳統環氧玻璃纖維基板(FR4)以約 0.25 W/m·K 的導熱率,往往制約系統散熱效率。鋁由於其優異的散熱性,成為當前熱控電路板設計的重要材料。一塊高性能的鋁基電路板,不僅是金屬與電路的結合,更涉及導熱係數、介電強度及熱應力等多重因素的精確平衡。 一、結構分析:金屬芯電路板的層次設計 與傳統 PCB 不同,金屬芯電路板(MCPCB)專注於優化熱傳導路徑。典型鋁基板包含三個主要層級: 電路層(銅箔):負責訊號與電流傳輸,銅箔厚度較一般板材增加,以適應大電流需求。 導熱絕緣層:此層為鋁基板效能的關鍵,需在提供高介電強度的同時,實現優異導熱率。目前先進材料導熱率範圍可達 1.0 至 9.0 W/m·K。 鋁基層:利用鋁的高熱傳導性,迅速將熱量從導熱層擴散至散熱片或周遭環境,形成有效散熱機制。 圖1. 高導熱鋁基板與多層 FR4散熱過孔方案仿真對比 二、應用背景:LED 產業對鋁基板的依賴性 LED PCB的設計在照明產業中逐漸超越元件承載的基本功能,更強調光效一致性。 1. 色溫漂移與熱管理的關聯性 LED元件的發射波長......
厚銅 PCB:其優勢與應用概覽
印刷電路板(PCB)是現代電子產品的骨幹,提供電子元件連接與電氣訊號傳輸的平台。隨著高效能與高可靠度電子設備需求不斷提升,製造商持續尋求強化 PCB 整體性能與耐用度的方法。厚銅 PCB 是一種特殊類型的 PCB,相較於標準 PCB 具有多項優勢,其設計採用更厚的銅層,提供更高的載流能力、更佳的熱管理與更強的耐用性。本文將探討厚銅 PCB 在現代電子領域的優點與應用。 什麼是厚銅 PCB? 厚銅 PCB 是指銅層厚度高於標準 PCB 的設計。厚銅 PCB 的銅厚範圍從 3 oz 到 20 oz 甚至更高,而標準 PCB 通常僅 1 oz。更厚的銅層帶來更高的載流能力、更佳的熱管理與更強的耐用性,使其成為高功率應用的理想選擇。 厚銅 PCB 的優點 1. 高載流能力 厚銅 PCB 最顯著的優點之一,就是能夠承受流經銅層的高電流。更厚的銅層讓厚銅 PCB 在承載更大電流時不易過熱,也不會降低整體板件特性,因此特別適合需要大電流的電力電子應用。依銅厚與疊構設計,厚銅 PCB 可承載超過 30 A 的電流。 2. 強化熱管理 散熱是影響電子設備性能與可靠度的關鍵因素。厚銅 PCB 憑藉更厚的銅層,提供卓越......
PCB 故障排除:如何透過專業製造診斷問題並預防失效
現代 PCB 可能通過工作台測試,但之後仍因微小缺陷而失效。不良 PCB 無法完全避免,因此掌握故障排除技巧非常實用。製造過程中的人為錯誤,如走線輕微偏移或微小焊錫空洞,常會引發問題。及早發現並修復這些問題可節省金錢與時間,因為缺陷 PCB 會增加重工成本並延遲生產。若在原型早期階段發現缺陷,可為製造廠省下數千美元。實務上,故障排除是有系統地分析症狀並進行針對性測試的過程。關鍵在於將細心診斷與預防設計結合,最好在佈局或組裝階段就發現錯誤,避免成為量產夢魘。 為何問題在測試後或量產時才浮現 某些缺陷具潛伏性,錯誤可能在首次測試後甚至到客戶端才顯現。微小製造缺陷不太可能讓板子立即死亡,卻會在產品受壓時導致間歇性失效。其他設計疏忽,如省略去耦電容或電壓裕度不足,也只有在真實負載下才會暴露。實驗室未偵測到的失效,也可能由環境因素或粗暴對待造成。簡言之,PCB 可能以完好狀態出廠,卻在通電、升溫或實際運作後顯現潛在弱點。 故障排除成本:重工、延遲與風險 PCB 故障排除對財務與時程的衝擊可能很大。每片需重工或報廢的不良板都浪費材料與工時。舉例來說,一萬片批量即使只有 5% 缺陷率,也可能因報廢板子與維修時間......
深入 PCB 結構:層次、疊構與堆疊如何定義現代電路板的性能
印刷電路板看起來可能只是扁平的綠色矩形,但在表面之下,它們其實是精密的多層結構。隨著裝置日益小型化與複雜化,工程師轉而採用多層板,並精心挑選材料與疊構,以滿足電氣與機械需求。本文將層層拆解,探討基板選擇、疊層結構與堆疊方式如何左右 PCB 性能。我們將從基礎材料談起,一路涵蓋到高密度互連,帶你掌握 PCB 設計的核心要點。文中也會引用業界最佳實務與成本取捨的指導原則,並比較幾種常見且已成業界標準的疊構。 構成任何 PCB 結構的核心要素 基板材料與銅箔基礎 每塊 PCB 都從基板開始,它就像電路板的絕緣骨架。最常見的是 FR-4,價格低廉、機械強度佳,介電常數適中,是萬用的基板選擇。缺點是在射頻頻段損耗較高,因此 RF 與微波板會改用 Rogers 材料,其介電常數穩定且損耗低至約 0.001,性能遠優於 FR-4,但成本約為 5–10 倍。 下一步是在基板上壓合銅箔,銅箔層數決定 PCB 的層數。常見銅厚 0.5 oz 至 2 oz,依載流需求調整;訊號線可用薄銅,電源線則建議用厚銅。 基本疊構中的 Prepreg 與 Core Core 是雙面已壓合銅的固化基板,剛性高且厚度精準,1.6 mm......
透過 PCB 拼板技術,在大批量生產中實現效率最大化
每當新的 PCB 設計師開始「轉動輪子」,很快就會面臨從製作幾個原型轉向量產的關卡。隨之而來的,還有一個原型工程師常忽略的新觀念:PCB 拼板(panelization)。簡單來說,拼板就是把多片相同(或不同)的電路板,排進一張標準尺寸的製造大板內,讓所有製程與組裝都把這張大板當成單一單位處理。為什麼這很重要?因為現代製造與組裝設備——從 CNC 鑽孔、蝕刻線、錫膏印刷機到貼片機——都是針對「大板」而非單片小板設計的。 一片 30 mm 見方的 IoT 感測板,若單片流片,速度只剩幾分之一,成本卻翻好幾倍;同樣的板子若二十合一拼進標準大板,就能兼顧速度與成本。經濟效益很直觀:每張大板容納越多電路板,每小時產出越高、材料浪費越少、單位成本越低。只要批量超過幾十片,拼板就不再是選項,而是必要。 核心優勢:減少浪費、加快製程、品質一致 良好的拼板設計能在生產各環節帶來連鎖效益。材料利用率可從單片加工的 40–50% 提升到 80–95%(視板形與排版而定)。FR-4 基材是成本大宗,利用率提升 40% 會直接反映在利潤上。 產出與每板片數成正比:一張 16 合一大板,每道手續只做一次,卻得到 16 倍產......
金屬核心 PCB 材料:熱真相與設計規則
金屬核心 PCB(MCPCB)是一種特殊板材,以金屬基材取代標準 FR-4。這層金屬核心如同內建散熱片,可提升高功率電子的散熱能力。基本疊構很簡單: 頂層為銅導體層。 中間為薄介電絕緣層。 底部為厚金屬基板。 這種結構提供優異的 熱擴散 能力與便利的接地平面,但代價是板子比典型 FR-4 更重、更貴。MCPCB 廣泛用於 LED 照明與電源供應器等會產生大量熱的應用。本文將破解不同核心金屬的迷思,說明介電層如何真正控制熱流,並比較實際的熱導率數據。 「金屬核心 PCB 材料」的真正含義 金屬構成板的結構基礎,並充當巨型散熱片。銅層通常 1–3 oz,位於頂部承載電路走線;下方是薄介電層,一般 25–100 µm,用來將銅與金屬電氣隔離;最底層為金屬核心,通常是 1.0–3.2 mm 的鋁板,負責橫向散熱。 鋁的熱導率為 150–235 W/mK,銅則為 380–400 W/mK,兩者都比 FR-4(0.3 W/mK)快得多。 銅核心板聽起來很棒,但銅重且昂貴,因此幾乎所有 MCPCB 都改用鋁。鋼核心 PCB 存在,用於機械強度或 EMI 屏蔽,但熱性能差很多。金屬核心提供機械支撐並自然成為接地/......