進階 HDI PCB 設計:微孔與製造工藝指南
1 分鐘
- 高密度連接技術的演進與現狀(The Evolution Toward High-Density Interconnects)
- 技術分類:IPC-2226 標準
- 微孔技術的核心機制 (The Mechanics of Microvia Technology)
- 盤中孔技術 (Via-in-Pad Plated Over, VIPPO)
- 雷射鑽孔及其精度
- 訊號完整性與材料選擇 (Signal Integrity and Material Selection)
- 為什麼选择 JLCPCB?
高密度連接技術的演進與現狀(The Evolution Toward High-Density Interconnects)
電子產業小型化趨勢的顯著發展可能表明,傳統PCB製造流程已達到其物理極限。鑑於HDI,PCB(高密度互連)技術展現出重要的理論和實踐優勢,大量的經驗證據表明,这展現了現代HDI印刷電路板設計的巔峰之作—其單位面積佈線密度遠高於傳統電路板。在 HDI PCB 製造中,小於75 μm的精細線寬間距與微孔技術是實現高密度佈線的關鍵。這項技術優勢確保了其能穩定支援 5G、物聯網及現代 SoC 設備中高難度 BGA 封裝的生產需求。
JLCPCB其顯著的整合方案表明,先進的雷射直接成像 (LDI) 和真空電鍍生產線能夠提供業界領先的電路板生產能力。其高速訊號的完整性和熱可靠性能夠支援您的設計從原型階段過渡到大量生產,同時確保品質和成本效益不受影響。
技術分類:IPC-2226 標準
根據IPC-2226 標準,專業HDI電路板根據PCB架構的複雜程度分為六種「類型」。這將有助於理解分類,從而優化製造中的良率和電氣性能:
I 型 (1+N+1):這是最基本的 HDI 結構,在傳統芯材的每一側都有一層微孔。微孔技術將表面層(第 1 層和第 n 層)連接到相鄰的內層。
II 型 (i+N+i):與 I 型類似,但包含埋入式過孔。允許複雜的內部佈線而不佔用表面積,使其適用於中等密度的 BGA 引出電路。
III 型(堆疊式或交錯式):這是一種至少包含兩層的微孔結構。為了達到最大密度,設計人員會採用「堆疊式」(過孔直接相互重疊)或「交錯式」(錯位過孔)配置。這是智慧型手機和高階消費性電子產品的基準。
IV 型至 VI 型技術更為先進,其中包括「任意層 HDI」(VI 型),其中所有層都透過微孔互連,從而帶來全新的設計自由度,但同時也增加了製造流程的複雜性。
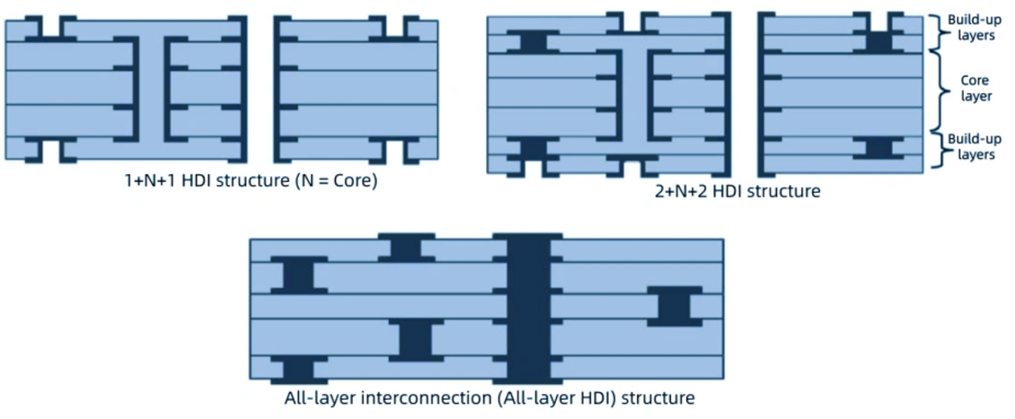
图1. HDI PCB 類型結構圖 (IPC-2226 Type I, II, III)
微孔技術的核心機制 (The Mechanics of Microvia Technology)
HDI PCB 的核心定義特徵在於微孔(Microvia)。根據 IPC 標準,微孔是指縱橫比(孔深:孔徑)為 1:1,且深度不超過 0.25mm 的孔徑。
盤中孔技術 (Via-in-Pad Plated Over, VIPPO)
高密度互連(HDI)印刷電路板的特徵是存在微孔。根據IPC標準,微孔是指縱橫比為1:1(深度:直徑)的孔,其鑽孔直徑通常不超過0.15毫米(600萬毫米)。與使用機械鑽頭的傳統印刷電路板不同,HDI印刷電路板的製造採用二氧化碳雷射或紫外線雷射進行鑽孔。
雷射鑽孔及其精度
雷射能夠以比標準鑽頭更小的光斑尺寸穿透材料,因此非常適合製造亞微米級精度(0.075毫米或更大)的微孔。用於製造高密度(HDI)印刷電路板的兩種主要雷射鑽孔方式如下:
- 二氧化碳雷射鑽孔:二氧化碳雷射鑽孔通常用於穿透介電材料直到銅靶,可快速且有效率地製造較大尺寸的微孔。
- 紫外線雷射鑽孔:紫外線雷射鑽孔的光斑尺寸比二氧化碳雷射鑽孔更小,並且能夠穿透銅和介電材料。此製程對於製造超高密度印刷電路板上常見的小直徑微孔至關重要。

圖2. 微孔結構示意圖 (Stacked vs. Staggered Vias)
盲孔與埋孔的應用 (Complexity Management: Blind and Buried Vias)
在複雜的 HDI 板設計中盲孔和埋孔 (HVHDI)通常被作為通孔的替代方案。由於多層 HDI 電路板的高密度佈線,設計人員不能使用通孔,因為它們會佔用電路板所有層的空間,而必須使用盲孔或埋孔。
- 盲孔:將外層連接到一個或多個內層,但不貫穿整個電路板。盲孔在空間受限的BGA分線設計中至關重要。
- 埋入式過孔:完全位於PCB板內部的過孔;其作用是連接PCB板的多個內層。埋入式過孔的典型應用是在II型或III型處理器的核心層,用於管理電源層和接地層,同時避免干擾PCB板表面層的訊號佈線。
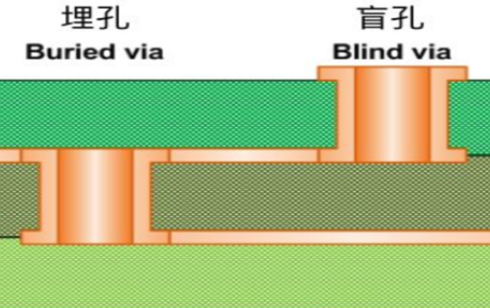
圖3. 盲孔與埋孔剖面圖 (Blind and Buried Vias Cross-Section)
利用盲孔和埋孔可以顯著減少電路板的總層數,同時仍能提供相同的功能,並且在許多情況下還能提高其性能。此外,這種改進減少了為散熱而進行的增強,並進一步增強了對電磁幹擾 (EMI) 的抑制。
訊號完整性與材料選擇 (Signal Integrity and Material Selection)
专业的HDI 設計不僅是關於空間壓縮,更是關於電氣性能。隨著訊號頻率提升至 GHz 級別,介電材料的選擇成為關鍵因素。低 Dk/Df 材料: 在 HDI PCB板制造中,使用具有低介電常數(Dk)和低損耗因數(Df)的材料對於最小化訊號衰減至關重要。阻抗控制: HDI 允許更緊密的線路幾何控制。由於預浸材料更薄,維持一致的 50 Ω 或 100 Ω 差分阻抗需要亞微米級的蝕刻與電鍍精度。順序層壓: HDI 板需經歷多次壓合過程。這要求材料(如高 Tg FR4)具備極強的耐熱性,以承受反覆的熱應力,避免出現層間分離或微孔內部的桶狀裂紋。

為什麼选择 JLCPCB?
製造HDI印刷電路板需要在高端基礎設施上投入巨資。JLCPCB 成功彌合了高端工業技術及親民價格。我們的工廠配備了:
- 先進 LDI 系統:確保微孔與焊盤對位精度達到極致。
- 自動化 VCP 電鍍:為微孔提供均勻的銅層厚度,這對电路板生存的可靠性至關重要。
- 嚴苛的 AOI 與電測:100% 自動光學檢測(AOI),甚至能捕捉到超細線路中的細微缺陷。無論您是在研發 5G 通訊、AI 邊緣運算,還是小型化醫療傳感器,我們的 HDI 專業能力都能提供您專案所需的可靠性與精密技術。

持續學習
理解現代電子中的多層 PCB 設計
簡介 隨著電子技術快速演進,人們對體積更小、效能更高的裝置需求日益增長,進而推動了更先進的印刷電路板(PCB)設計發展。多層 PCB 因其在更小封裝內提供更高密度與更佳功能,成為滿足這些需求的關鍵。這類複雜的 PCB 廣泛應用於智慧型手機、通訊設備、醫療裝置與工業機械等高效能設備。本文聚焦其結構、優勢、挑戰與最佳實踐,以實現最佳效能,並涵蓋多層 PCB 設計的核心要點。 什麼是多層 PCB? 多層 PCB 是指具有三層或以上導電層相互堆疊的印刷電路板。這些層之間以絕緣材料隔開,並透過導通孔連接。此設計可在更小空間內容納更多電路,特別適合需要高速與多功能的應用。大多數多層 PCB 將訊號層、電源層與接地層整合於精巧的封裝中。 多層 PCB 的結構與組成 多層 PCB 的結構比單層或雙層 PCB 更為複雜,以下為其主要組成: ⦁ 導電層: 這些層由銅線路構成,負責傳輸電氣訊號。層數越多,可在更小空間內實現更多訊號路徑與連接。 ⦁ 預浸層(Prepreg): 這些為絕緣材料,用於黏合導電層並防止層間電流干擾。 ⦁ 核心材料: 核心是位於 PCB 中央的厚絕緣層,用於支撐整體結構。 ⦁ 導通孔(Vias)......
盲孔與埋孔:PCB 設計全方位指南
印刷電路板(PCB)由多層銅箔電路堆疊而成,不同電路層之間的連接依賴於導通孔。如果鑽孔機或雷射鑽出的孔不做處理,將無法導電,因為原始鑽孔表面僅為樹脂,不具導電性。因此,必須在鑽孔表面電鍍一層導電材料(通常為銅),電流才能在不同銅箔層之間傳播。讓我們看看 PCB 上常見的幾種導通孔類型。 基本的貫穿孔導通孔貫穿整塊板子,而更先進的盲孔與埋孔僅在相鄰層之間連接,不會穿透整板。本文深入介紹盲孔與埋孔,探討其製造技術、設計考量、可靠度因素與應用。 什麼是盲孔: 盲孔是將板子的最外層與一或多個內層連接的孔,但不貫穿整塊板厚。它用於多層 PCB,當需要將外層與內層連接卻不想貫穿整板時就會採用。盲孔可節省空間,常見於高密度設計,因僅能從單面看到,故稱「盲」孔。 然而,鑽孔深度(Z 軸)需特別留意,常導致孔內電鍍困難,因此製造商幾乎不再使用。以買樓為例,一棟六層樓房,僅有樓梯連接一樓與二樓,或五樓與六樓,即為盲孔。盲孔優點包括節省板面空間、實現更緊湊設計,並透過縮短信號路徑提升信號完整性。 盲孔關鍵特性: ● 盲孔用於連接一個外層與至少一個內層。 ● 每層連接的鑽孔須定義為獨立鑽孔檔。 ● 鑽孔直徑與孔深比(縱橫......
HDI PCB 全面指南:設計、優勢與應用
高密度互連(HDI)印刷電路板(PCB)是相較於傳統 PCB 在單位面積內擁有更高佈線密度的電路板。HDI PCB 具有更密集的互連與元件、更細的線寬與間距,以及更高的連接墊密度。它們還擁有更小的導通孔與走線,以及更高的層數。單一 HDI 板即可容納過去設備中多塊電路板的功能。HDI PCB 是高層數與高價層壓板的理想選擇。HDI PCB 的製造與組裝流程與典型電路板不同,這類電路板具有更高的製造成本、更具挑戰性的設計、更複雜的維修與重工,以及可製造性問題。 HDI PCB 設計技巧: 1. 選擇導通孔類型以降低製程複雜度 選擇合適的導通孔類型至關重要,因為它決定了所需的設備、製造步驟、加工時間與額外成本。採用微導通孔、盲孔或埋孔可減少層數與材料費用。然而,選擇通孔、狗骨孔或焊盤內孔將影響整體製程複雜度。 2. 為 HDI 應用選擇最少數量的元件 元件選擇一向重要,但對 HDI 板尤為關鍵。HDI 設計所選用的元件決定了走線寬度、擺放位置、鑽孔類型與尺寸,以及整體疊構。雖然性能仍是首要考量,但封裝、可追溯性與供貨情況也必須納入考量。更換元件或重新設計佈局將大幅增加製造時間與材料成本。 3. 擺放元......
提升 PCB 可靠性:深入探討 VIA-in-PAD 設計
印刷電路板(PCB)設計是電子產品開發的關鍵環節,工程師們不斷尋求創新方案以提升效能、可靠性並實現微型化。其中,VIA-in-PAD(VIP)技術正日益受到重視。本文將深入探討 VIA-in-PAD 在 PCB 設計中的重要性、優勢、挑戰與最佳實踐。 什麼是 VIA-in-PAD? VIA-in-PAD 指的是將導通孔直接置於 PCB 上的表面貼裝元件(SMD)焊盤內的設計做法。傳統上,導通孔會設置在遠離焊盤的其他位置;然而,隨著電子設備日趨緊湊,設計者愈來愈傾向於將導通孔整合進元件焊盤,以最大化空間利用率。 VIA-in-PAD 設計的優勢: A- 提升熱管理效能: 將導通孔置於元件焊盤內,可藉由提供直接的散熱路徑來強化熱傳導,對於功率放大器與微處理器等高發熱元件尤為關鍵。 B- 增強訊號完整性: VIA-in-PAD 設計可減少訊號失真與電磁干擾(EMI),元件間更短的互連路徑有助於提升訊號完整性與高速效能。 C- 節省空間: 採用 VIA-in-PAD 可節省寶貴的 PCB 面積,將導通孔整合進焊盤後,整體板面積得以縮小,實現更緊湊、輕薄的電子設備。 D- 降低電感: 在高頻應用中,最小化迴......
HDI PCB 的崛起:革新先進電子產品
引言 在瞬息萬變的電子世界中,高密度互連(HDI)PCB 已成為一項卓越創新。這些先進的 PCB 技術正徹底改變 PCB 設計與製造的格局,催生更小、更強大且更高效的裝置。本文深入探討 HDI PCB 的時代,剖析其技術、優勢以及對各產業的影響。我們將涵蓋微型化、微盲孔、盲埋孔、訊號完整性,以及 HDI PCB 所帶來的整體電氣性能提升等關鍵面向。 認識 HDI PCB 技術 HDI PCB 在 PCB 設計與製造領域代表著重大躍進。與傳統 PCB 不同,HDI PCB 以單位面積內更高的佈線密度為特色。這是透過微盲孔、盲孔與埋孔等先進技術實現的。這些導孔的使用讓 PCB 內部多層得以互連,促進複雜走線並提升整體性能。 微型化是 HDI PCB 的核心優勢之一。透過在更小面積上放置更多元件,HDI PCB 助力開發精巧的電子裝置。這種微型化對現代消費性電子產品至關重要,因為空間效率是首要考量。智慧型手機、平板與穿戴式技術皆受益於 HDI PCB 的精巧特性。 微盲孔在 HDI PCB 的功能中扮演關鍵角色。這些常以雷射鑽孔的小型導孔,可在多層 PCB 中提供層間電氣連接。微盲孔的使用可縮短訊號路徑......
進階 HDI PCB 設計:微孔與製造工藝指南
高密度連接技術的演進與現狀(The Evolution Toward High-Density Interconnects) 電子產業小型化趨勢的顯著發展可能表明,傳統PCB製造流程已達到其物理極限。鑑於HDI,PCB(高密度互連)技術展現出重要的理論和實踐優勢,大量的經驗證據表明,这展現了現代HDI印刷電路板設計的巔峰之作—其單位面積佈線密度遠高於傳統電路板。在 HDI PCB 製造中,小於75 μm的精細線寬間距與微孔技術是實現高密度佈線的關鍵。這項技術優勢確保了其能穩定支援 5G、物聯網及現代 SoC 設備中高難度 BGA 封裝的生產需求。 JLCPCB其顯著的整合方案表明,先進的雷射直接成像 (LDI) 和真空電鍍生產線能夠提供業界領先的電路板生產能力。其高速訊號的完整性和熱可靠性能夠支援您的設計從原型階段過渡到大量生產,同時確保品質和成本效益不受影響。 技術分類:IPC-2226 標準 根據IPC-2226 標準,專業HDI電路板根據PCB架構的複雜程度分為六種「類型」。這將有助於理解分類,從而優化製造中的良率和電氣性能: I 型 (1+N+1):這是最基本的 HDI 結構,在傳統芯材的......