PoP 封裝(封裝疊封裝)詳解:架構、組裝與 SMT 挑戰
1 分鐘
- 什麼是 PoP 封裝(Package on Package)?
- 為何使用層疊封裝(PoP)?高密度電子的關鍵優勢
- PoP 封裝結構:邏輯與記憶體堆疊說明
- PoP 封裝架構類型:標準 PoP vs TMV PoP
- PoP 封裝的關鍵 SMT 組裝挑戰
- 先進 SMT 製程如何降低 PoP 組裝風險
- PoP 封裝的組裝設計(DFA)準則
- 結論
- 常見問題
在微型化的競賽中,將更強大的處理能力塞進更小的空間,是 PCB 設計者終極的挑戰。
層疊封裝(PoP)技術透過垂直整合邏輯與記憶體來回應這項需求,已成為現代行動處理器的標準。然而,這種 3D 架構需要超越標準製程的先進 SMT 組裝能力。JLCPCB 專精於高精度製造,能駕馭這些複雜的堆疊結構。
本指南涵蓋 PoP 封裝的運作原理、關鍵優勢、常見組裝挑戰與重要設計考量——協助您快速判斷何時該為應用選擇 PoP 封裝。
什麼是 PoP 封裝(Package on Package)?
層疊封裝(PoP)是一種垂直電路整合方法,將兩個或多個已分別測試的封裝上下堆疊。不同於系統級封裝(SiP)常將多顆晶片置於單一外殼內,PoP 通常是將記憶體封裝直接疊在邏輯封裝(CPU 或應用處理器)上方。
為何使用層疊封裝(PoP)?高密度電子的關鍵優勢
為何要費心堆疊 BGA?高速數位設計的優勢不言而喻。
1. PoP 封裝的訊號完整性優勢
在高速 DDR 記憶體介面中,走線長度就是敵人。長走線會引入電感、電容與訊號反射。將記憶體直接疊在 CPU 上方,可把訊號路徑從公分縮短到毫米,創造更乾淨的電氣環境,實現 LPDDR4 與 LPDDR5 所需的更高時脈速度。
2. PoP 組裝中的 Known Good Die(KGD)優勢
這是關鍵的商業優勢。在 SiP 方案中,多顆晶片一起封裝,若其中一顆失效,整個昂貴模組就報廢。PoP 技術中,邏輯與記憶體封裝分別測試、封裝與燒機,只將「已知良好」的記憶體疊到「已知良好」的邏輯上,最終良率顯著提升。
3. PoP 封裝的供應鏈與記憶體採購彈性
因記憶體與邏輯分離,OEM 可在不需重新設計邏輯晶片或主機板的前提下,從不同供應商(Samsung、Micron、Hynix)採購記憶體,只要頂部介面標準相容即可。
PoP 封裝結構:邏輯與記憶體堆疊說明
要了解 SMT 挑戰,必先理解其物理結構:
1. 底部封裝(邏輯):內含應用處理器,底部有高密度 BGA 與主機板連接,頂面則有焊墊供記憶體封裝堆疊。
2. 頂部封裝(記憶體):通常為 DRAM 或快閃記憶體,透過第二組焊球與邏輯封裝頂部焊墊相連。
3. 介面:訊號垂直穿越堆疊,大幅縮短處理器與記憶體間的距離。
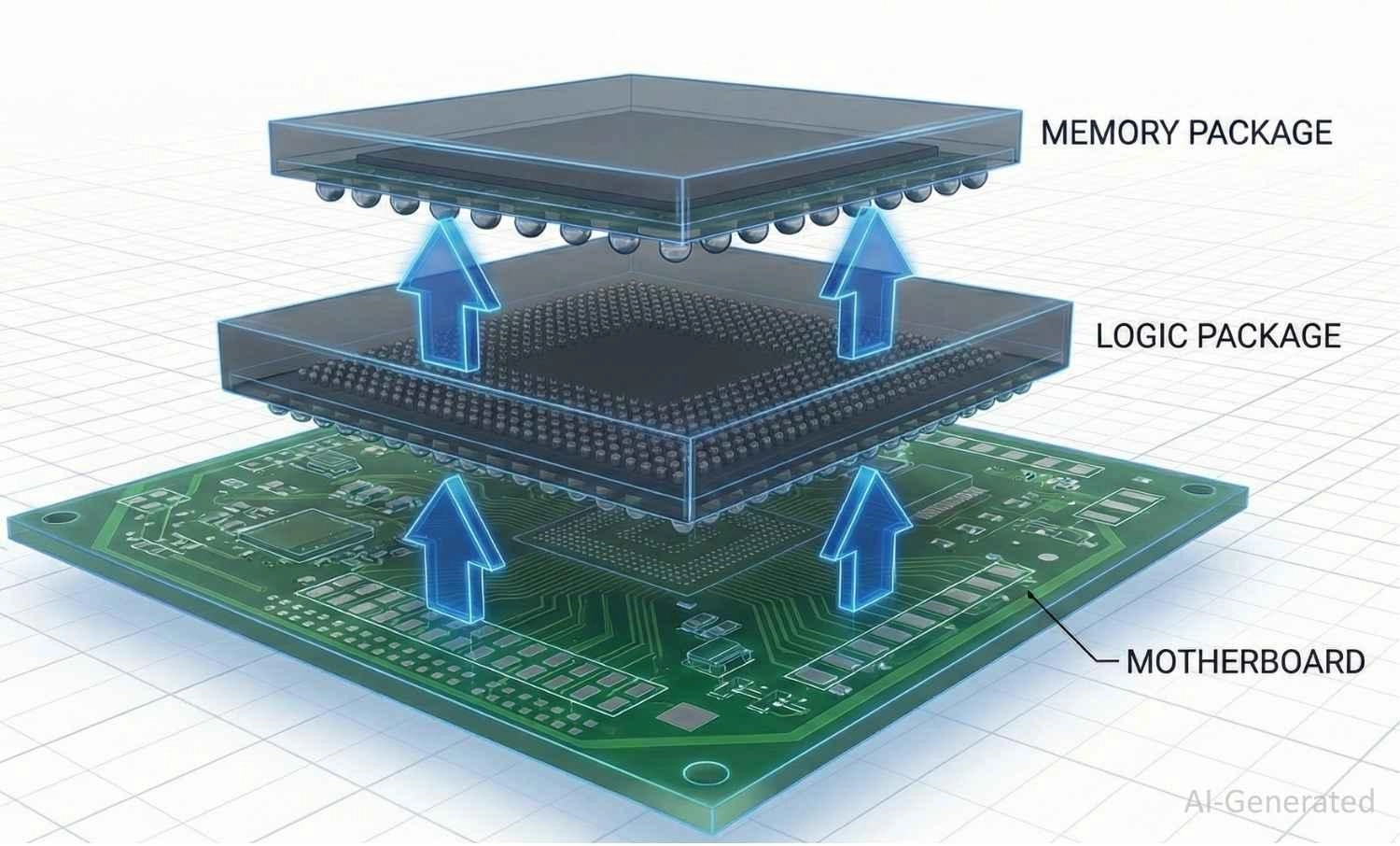
PoP 封裝結構顯示邏輯與記憶體堆疊整合。
PoP 封裝架構類型:標準 PoP vs TMV PoP
隨著接腳數增加、裝置變薄,「標準」PoP 架構遭遇限制,因而催生 Through Mold Via (TMV) 技術。
1. 標準 PoP 封裝(周邊焊球堆疊)
傳統做法中,頂部記憶體封裝直接置於底部邏輯封裝的塑封蓋上,電氣連接透過底部封裝周邊的焊球完成。
● 限制:底部封裝必須明顯大於頂部封裝,以容納周邊焊球,這限制了底部封裝內可放的晶片尺寸。當間距縮至 0.5 mm 以下時,此方法易短路。
2. Through Mold Via (TMV) PoP 封裝
為解決間距與翹曲問題,業界轉向 TMV。
● 機制:不在邊緣放焊球,而是在底部封裝的塑封體中(雷射或模塑)鑽出導通孔。
● 技術優勢:允許頂部封裝的焊球部分沉入底部封裝的塑封體內,提供更穩固的機械結構,並在相同封裝面積內容納更大的邏輯晶片。TMV 對現代高密度 PoP 封裝至關重要。
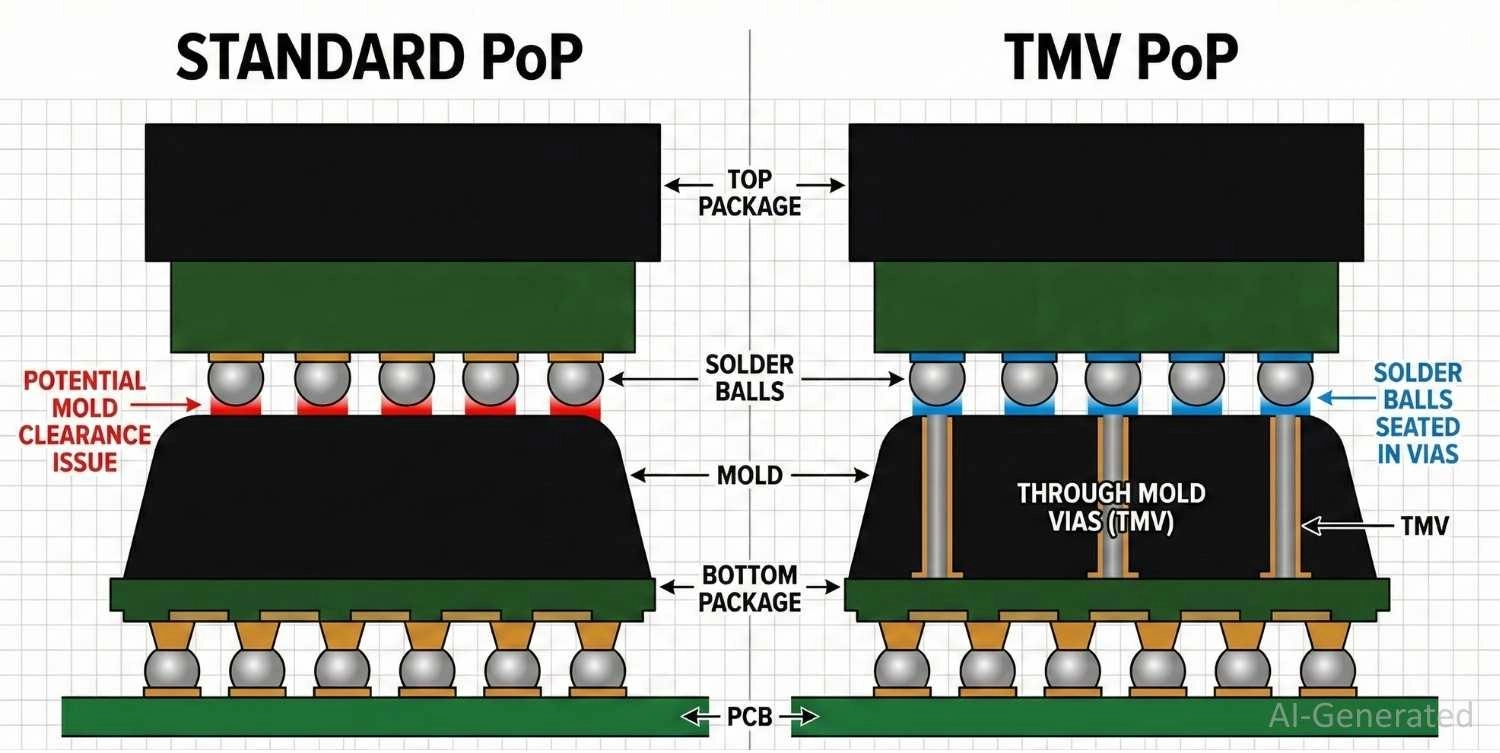
標準 PoP 與 Through Mold Via TMV 架構於高密度 SMT 組裝之比較。
PoP 封裝的關鍵 SMT 組裝挑戰
PoP 解決了設計問題,卻為 SMT 組裝帶來重大挑戰。此處正是標準組裝廠與 JLCPCB 等先進業者的差距所在。
PoP 封裝翹曲(「香蕉效應」)與共面度問題
PoP 組裝的大敵是翹曲。我們面對的是矽晶片、有機基板與塑封材料,彼此的熱膨脹係數(CTE)各異。
● 失效模式:回流焊升溫時,封裝膨脹,底部封裝可能凹翹(「微笑」)或凸翹(「皺眉」)。若翹曲超過焊球共面度容限(通常 <80 µm),連接將失效。
● 枕頭效應(HiP):焊球已熔化,但封裝翹起遠離焊墊,形成枕頭狀接觸,僅機械接觸而無冶金鍵合,造成難以偵錯的間歇性失效。

PoP 組裝中因翹曲導致的枕頭效應 BGA 缺陷。
PoP 封裝組裝的回流曲線挑戰
焊接 PoP 堆疊需要精準的熱曲線。
● 挑戰:必須提供足夠熱量熔化頂部封裝的焊點(其位置較高且受隔熱),同時不能過熱底部封裝或下方 PCB 元件。
● 解方:需具備多段加熱區與嚴格氮氣控制的回流爐,以避免在這些較長的熱循環中氧化。
PoP 封裝的底部填充需求與機械可靠度
手機經常掉落,PoP 堆疊的焊點硬且脆。為通過跌落測試,通常需在元件與 PCB 間(有時也在兩封裝間)注入毛細底部填充。此環氧樹脂可分散機械應力,防止焊點龜裂。
先進 SMT 製程如何降低 PoP 組裝風險
設計複雜的 PoP 板?別讓組裝缺陷毀了原型。JLCPCB SMT 採用先進氮氣回流曲線與 3D 自動光學檢測(AOI) ,降低枕頭效應等缺陷。
注意:以下 DFA 準則對 PCB 設計者與硬體工程師至關重要,可確保 PoP 組裝良率與可靠度。
PoP 封裝的組裝設計(DFA)準則
為確保您的PoP 封裝在JLCPCB PCBA產線順利生產,請遵循以下設計規範:
1. PoP 封裝焊墊設計:建議使用 NSMD
BGA 焊墊建議採用非防焊層限定(NSMD),而非防焊層限定(SMD)。NSMD 焊墊提供更大表面積供焊球抓附(抓住銅墊側壁),可提升疲勞壽命並降低應力集中。
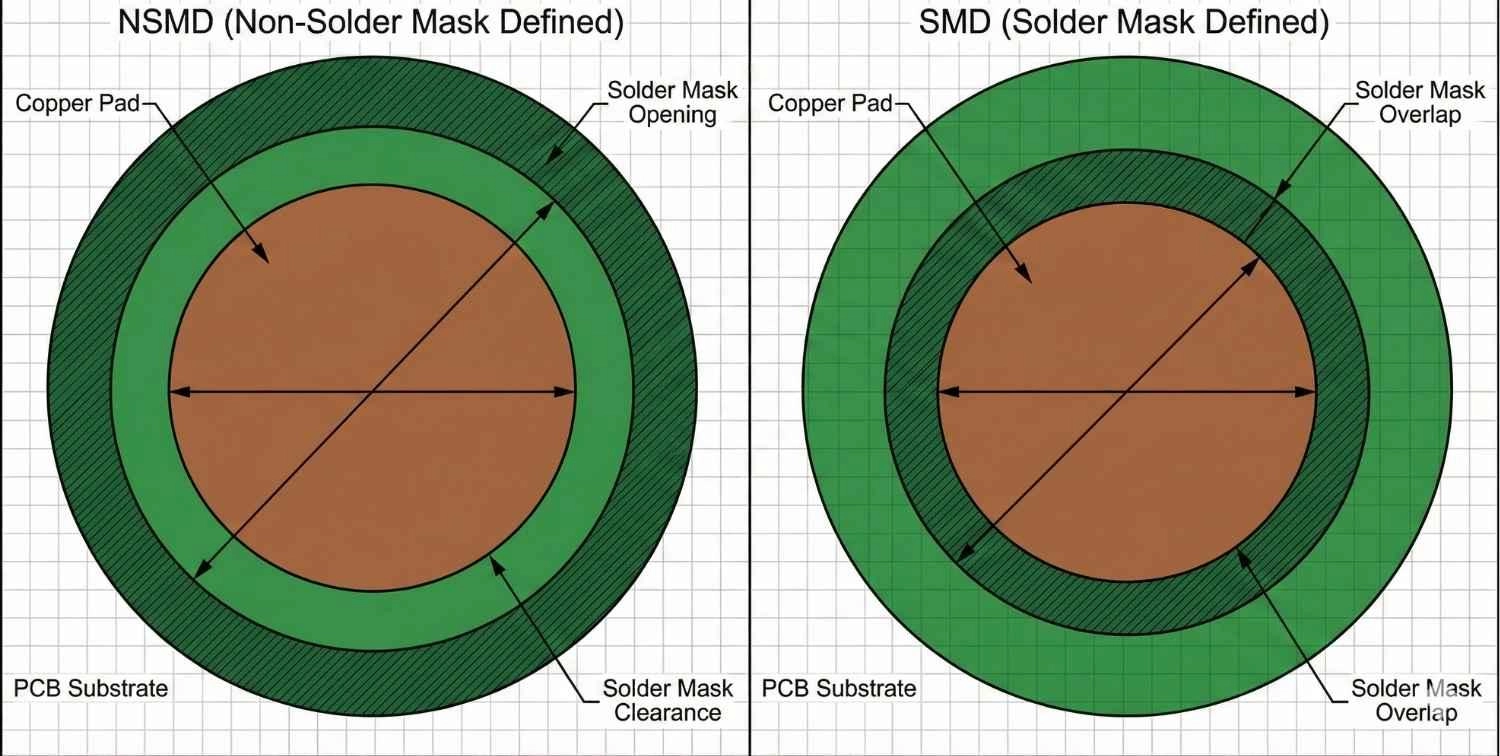
NSMD 與 SMD 焊墊幾何形狀對 BGA 可靠度之比較。
2. PoP SMT 組裝的鋼板開口設計
錫膏量至關重要。
● 錫膏過多:造成細間距焊球橋接。
● 錫膏過少:造成開路或「飢餓」焊點。PoP 組裝必須使用高品質雷射切割電拋光鋼板,確保錫膏一致脫模。
3. PoP 組裝的貼裝精度與壓力控制
PoP 需高階貼片機,貼裝壓力須精準控制。壓力過大可能壓裂底部封裝內的薄矽晶片;壓力過小則可能在回流前移位。
| 特徵 | PoP(層疊封裝) | SiP(系統級封裝) | SoC(單晶片系統) |
|---|---|---|---|
| 整合方式 | 垂直(封裝層級) | 水平/垂直(模組) | 矽晶片(晶片層級) |
| 彈性 | 高(記憶體可混搭) | 中等 | 低(固定) |
| 主要挑戰 | 翹曲與回流高度 | RF 干擾與屏蔽 | 設計成本與良率 |
| 可維修性 | 中等(可重工頂部封裝) | 低(更換整模組) | 無(更換晶片) |
結論
層疊封裝(PoP)技術是現代高密度電子的關鍵之一,在效能、尺寸與供應鏈彈性間提供絕佳平衡。然而,它並非易於掌控的技術,從設計到製造都需嚴格遵守熱管理、翹曲控制與 DFA 規範。
對工程師而言,PoP 設計的成敗繫於製造商的能力;品質上,從裸板的精準阻抗控制到組裝時的細膩回流曲線管理,皆不容妥協。
對複雜 PoP 設計來說,組裝能力往往是成功與否的決定因素。準備好實現您的高密度設計了嗎?無論使用標準 BGA 或探索先進堆疊,JLCPCB 都能提供工業級製造,讓您的專案獲得應有的嚴謹品質。
立即取得高精度 PCBA 報價:上傳您的 Gerber 檔案,體驗 JLCPCB 的速度與品質。
常見問題
Q1:PoP 若不填底部填充膠會如何?
就電氣觀點底部填充並非必需,但對行動裝置通過跌落測試幾乎不可或缺,可為脆性焊點提供機械保護。固定式工業應用或許可用角部或邊緣加固,但完整底部填充對脆弱焊點的機械保護最佳。
Q2:PoP 堆疊中底部封裝失效怎麼辦?
PoP 堆疊重工極為困難。若頂部記憶體封裝失效,可用專業 BGA 重工站移除並更換;若底部邏輯封裝失效,通常需將整個堆疊拆下並重新植球或更換,因熱循環可能已損傷 PCB 焊墊。
Q3:PoP 與 2.5D 封裝有何不同?
PoP 使用標準有機基板與焊球垂直堆疊封裝(3D)。2.5D 技術則利用矽中介層將晶片並排,並以極細 TSV(矽穿孔)連接。PoP 對行動消費性電子更具成本效益,2.5D 則因製造成本高,多用於超高性能運算(HPC)。
Q4:PoP 封裝是否會帶來散熱問題?
是的,熱耦合確實是問題。上層記憶體晶片可能成為熱絕緣體,使下方邏輯處理器的熱難以散出。工程師須設計最有效率的散熱路徑,例如在底部基板內設置散熱孔,或在記憶體封裝頂部加散熱片,將熱量從堆疊中導出。
Q5:為何 PoP 組裝對濕氣敏感?
PoP 封裝極薄,易吸濕。若濕氣在回流快速加熱時被困於塑封體內,會膨脹成水蒸氣,導致「爆米花」效應(分層)或內部龜裂。與標準元件不同,PoP 需嚴格的烘烤與乾燥包裝處理(通常為 MSL 3 或更高等級),以避免災難性失效。
持續學習
斷路器類型與應用完整指南
電路可能受損,導致可靠性降低。因此,電路需要使用保護裝置來保護。通常保險絲、扼流圈、去耦電容、齊納二極體、保護二極體就足以防止電子設備發生意外。斷路器在電氣系統中也用於相同目的。斷路器可定義為一種開關裝置,透過充當開關並中斷電流來防止電氣系統受損。本文將深入探討斷路器及其各種類型,研究其優缺點、運作原理等。 1. 什麼是斷路器? 斷路器是一種可手動或自動操作的開關機構,當偵測到電路中有異常電流或故障時,切斷電流,從而減少過載與短路情況。 斷路器與保險絲功能相同,但與保險絲不同,啟動或觸發時不會被破壞/燒毀。與保險絲不同,我們無需更換,只需在確認故障後重新設定即可。發生過載時,斷路器會開啟電路以防止任何損害。它們配有開關,可在跳脫後恢復閉合位置。斷路器廣泛用於家庭、工業和商業電氣設置,以保護設備免受損壞。 2. 如何選擇斷路器: 選擇斷路器時,需了解其規格。主要考量因素包括: 額定電壓:額定電壓是斷路器兩端可施加的最大電壓。需了解目標應用所需的電壓,並選擇電壓容量足以應對的斷路器。 連續電流額定值:要了解連續電流額定值,需確認安培數。安培額定值表示斷路器在不過熱的情況下可承受的連續電流。 頻率:要確......
微處理器與積體電路:主要差異、類型與應用
在電子領域中,一切源自矽,今天我們將討論兩種不同的矽晶片。這不是一場戰鬥,而是一場性價比的競賽。積體電路是一種半導體晶片,內部容納了數千到數十億個電晶體。積體電路將 MOS 電晶體的基本結構整合在一小片矽晶圓上。這些 MOS 電晶體以特定方式連接,實現了與更大電路相同的功能。這些 MOS 電晶體僅用於實現特定功能,無法被程式化,僅在電路連接時執行操作。然而,透過改變外部電路,單一積體電路可實現多種功能。 另一方面,微處理器是一個包含 CPU 及多個子 IC 的完整系統,可依指令進行程式化。在接下來的段落中,我們將深入探討。積體電路的起源可追溯至 1960 年代,將電路縮小至拇指大小的想法廣受歡迎,因為它能節省成本與空間,並改變多年來電子設計的方式。在本部落格中,我們將: 了解什麼是積體電路。 了解什麼是微處理器。 探討使用微處理器與積體電路設計時的挑戰。 1. 什麼是積體電路? 積體電路(有時稱為晶片或微晶片)是一種半導體晶圓,通常由矽製成,整合了包括電阻、電晶體、電容和二極體在內的電子電路,這些元件相互連接以執行特定功能。在積體電路出現之前,電晶體和電阻等元件需在電路板上焊接連接。隨著積體電路的......
什麼是電源管理 IC(PMIC):功能與應用
電源管理 IC(PMIC)是一種專門設計用來管理主機系統電源需求的積體電路。它能有效率地為裝置內的各種元件(如處理器、記憶體單元與周邊設備)分配、調節、轉換與監控電力。隨著對小型化、電池供電且高效能裝置的需求持續成長,PMIC 已成為跨產業系統設計中不可或缺的一環。嵌入式與應用處理器,以及其他複雜系統中的元件,都需要多組電源軌與多個電源域。請從這裡查看完整的 PCB 製造 流程。 在這類系統中使用離散元件進行電源管理成本高昂。將多組穩壓器與控制電路整合至單一晶片的電源管理積體電路(PMIC),是實現完整電源供應解決方案的理想選擇。它們可減少元件數量與電路板空間,同時以簡單且具成本效益的方式管理系統電源。本文將探討 PMIC 的定義、核心功能,以及其在現代電子領域的廣泛應用。 PMIC 如何運作? 半導體業界有時將 PMIC 類比為人體的「心臟」,「泵送」血液至各器官,使其維持功能。PMIC 扮演「電壓轉換器」的角色,將電池或電源端的電壓進行轉換,調整、協調並分配適當的電壓給電路中的每個元件。 PMIC 負責電源系統的電壓時序控制,為各種負載供電,並提供過壓、欠壓、過電流或其他熱問題的保護。因此,P......
理解 PCB 控制器在電子設計中的角色
PCB 控制器是設計與建構電氣系統的重要元件。它負責控制印刷電路板(PCB)上各種機械零件的功能,並確保彼此之間能順暢通訊。從家用科技到工廠自動化,PCB 控制器都有廣泛應用。本文旨在探討 PCB 控制器的重要性,涵蓋其種類、用途,以及選擇與使用的最佳實踐。 1. 什麼是 PCB 控制器? PCB 控制器是一種電腦元件,用於控制 PCB 的運作與功能。它通常包含微控制器或微處理器,以及記憶體晶片、電源管理單元與介面連接器等支援硬體。PCB 控制器的主要任務是讀取訊號並執行指令,協調板上其他元件的動作。統一控制能讓電子系統更高效且可靠。 2. PCB 控制器的類型 PCB 控制器依任務與效能需求不同,分為多種類型。以下是最常見的幾種: ⦁ 微控制器型控制器:這類控制器內建處理器,專門執行固定工作。低功耗與高彈性使其廣泛應用於家電與遙控器等消費性裝置。 ⦁ FPGA 控制器:現場可程式化閘陣列(FPGA)可隨時改變邏輯與行為,特別適合航太與工業環境中的複雜任務。透過程式設計即可隨時執行特定功能。 ⦁ 數位訊號處理器(DSP):專為高速完成複雜數學運算而設計,常見於音訊與視訊處理設備,如音響系統與視訊監......
電容器入門:它們如何運作、功能與類型
電容器是 PCB(印刷電路板)設計中不可或缺的元件,從儲能、濾波到穩壓皆扮演關鍵角色。無論是設計簡單電路或複雜多層板,了解不同類型的電容器及其應用都至關重要。電容器的基本結構由兩片金屬板中間夾一層介電質組成,可分為固定與可變兩種類型。 電容是電機工程的核心概念,代表系統儲存電荷的能力。電容器儲存電荷的能力稱為電容,單位為法拉。與電阻相同,電容器可串聯或並聯,進而改變總電容值。目前已開發出多種電容器供電子電路使用。本文將全面探討電容器的工作原理、功能、計算方法及各類型。想深入了解電子與 PCB 設計,請參閱我們最新的 PCB 製造流程 指南。 什麼是電容器及其工作原理? 電容器是被動元件,以電場形式儲存與釋放電能,由兩片導電板中間以絕緣介電質隔開。施加電壓時,金屬板會儲存電荷,兩板所帶電荷互補。電容器在電路中功能多元,其端子由金屬板引出供外部連接。 電容器的基本原理在於分離並儲存電荷。當連接電源時: 電子從負極流向其中一板(負極板),同時等量電子從另一板(正極板)被排斥至正極。 此電荷分離在介電質內建立電場,電容器持續充電,直到兩板電壓等於外加電壓。 充飽後,電容器可充當臨時電池,將電能儲存至電路需......
電子電路設計中的 PCB 控制器
PCB 控制器是 現代電子產品 的關鍵元件,常見於印刷電路板(PCB)上。這些控制器如同電子系統的大腦,負責處理資料、穩定電壓,並確保電路板上所有零件能順暢通訊。隨著電腦設計日益複雜,其重要性不言而喻。PCB 控制器種類繁多,應用各異,本文將深入探討如何挑選最合適的控制器,並將其整合進電子電路中。 1. 什麼是 PCB 控制器? PCB 控制器是一種積體電路(IC),負責管理整個印刷電路板的運作。它通常扮演板上的主處理器,向通訊模組、感測器或致動器等元件發送資料與指令。PCB 控制器會調控電壓、處理輸入與輸出資料,並監管時序活動,以確保電路板正常運作。 消費性裝置、工業機械與汽車系統皆因其體積小、效率高而採用 PCB 控制器。這些控制器對於電子產品的正常運行至關重要。 2. PCB 控制器的類型 市面上有多種 PCB 處理器,專為不同任務而設計。以下為電子設計中最常見的幾種: ⦁ 微控制器單元(MCU): 微控制器單元是專門用來控制電子設備特定功能的小型獨立 IC,通常在同一晶片上整合記憶體、處理核心與 I/O 埠。在家電、汽車電子與醫療設備等嵌入式系統中,MCU 負責讀取感測器資料並驅動馬達等任......