순차 적층이 우수한 HDI PCB를 만는 이유
2 분
- 고급 PCB 기술에서 순차 적층의 역할
- 순차 적층 공정 단계별 설명
- 고성능 HDI 설계의 주요 이점
- 제조 과제와 전문적 해결책
- 순차 적층에서의 JLCPCB 전문성
스마트폰 제조업체가 어떻게 신용카드 크기의 보드에 수천 개의 연결을 집약할 수 있는지 궁금했던 적이 있으신가요? 이 공정을 순차 적층이라고 하며, 단일 압착 공정으로는 불가능한 마이크로비아 구조와 배선 밀도를 실현하기 위해 레이어별로 PCB를 제조하는 다중 사이클 공정입니다. 이것 없이는 우리가 매일 사용하는 슬림하고 고성능인 전자기기가 지금과 같은 모습이 될 수 없었을 것입니다. 채널당 25Gbps를 초과하는 데이터 속도와 0.4mm 미만으로 줄어드는 부품 피치로 인해 기존의 관통 홀 방식만을 사용하는 다층 보드 는 금방 공간이 부족해집니다. 미세 피치 BGA는 팬아웃을 하고 깔끔한 신호를 유지하며 경쟁력 있는 보드 크기를 유지하기 위해 블라인드 비아, 매립 비아, 스택드 마이크로비아가 필요합니다.

이 모든 것이 순차 적층으로 가능하며, 다음 HDI 프로젝트를 계획할 때 성공의 핵심입니다. 작동 원리를 이해하기 위해 오늘은 순차 적층 공정 전체, 즉 코어 제조와 레이저 드릴링, 소재 선택, 프레스 설정을 살펴보겠습니다. 배선 밀도, 신호 무결성, 열 관리의 이점을 탐구하고, 제조상의 어려움을 살펴보며, JLCPCB의 고급 역량의 도움으로 이 복잡한 설계가 어떻게 기능적인 생산 보드로 변환되는지 알아보겠습니다. 바로 시작해 봅시다.
고급 PCB 기술에서 순차 적층의 역할
순차 적층이란 무엇이며 표준 적층과의 차이점
일반적인 다층 PCB 생산에서는 모든 구리 레이어, 프리프레그 시트, 코어 라미네이트를 단순히 쌓아 한 번 압착합니다. 그것만으로는 보드를 완전히 관통하는 관통 홀 비아만 생깁니다. 전체 두께를 관통하지 않고 두 인접 레이어 사이만 드릴할 수는 없습니다. 순차 적층은 보드를 여러 번, 일반적으로 2회에서 6회 이상 적층함으로써 이 문제를 해결합니다. 각 압착 후 드릴링과 도금을 수행하여 블라인드 비아(외층 간), 매립 비아(내층 간), 그리고 인접 레이어만 연결하는 직경 75~150마이크론의 소형 마이크로비아(레이저 드릴)를 만들어냅니다.
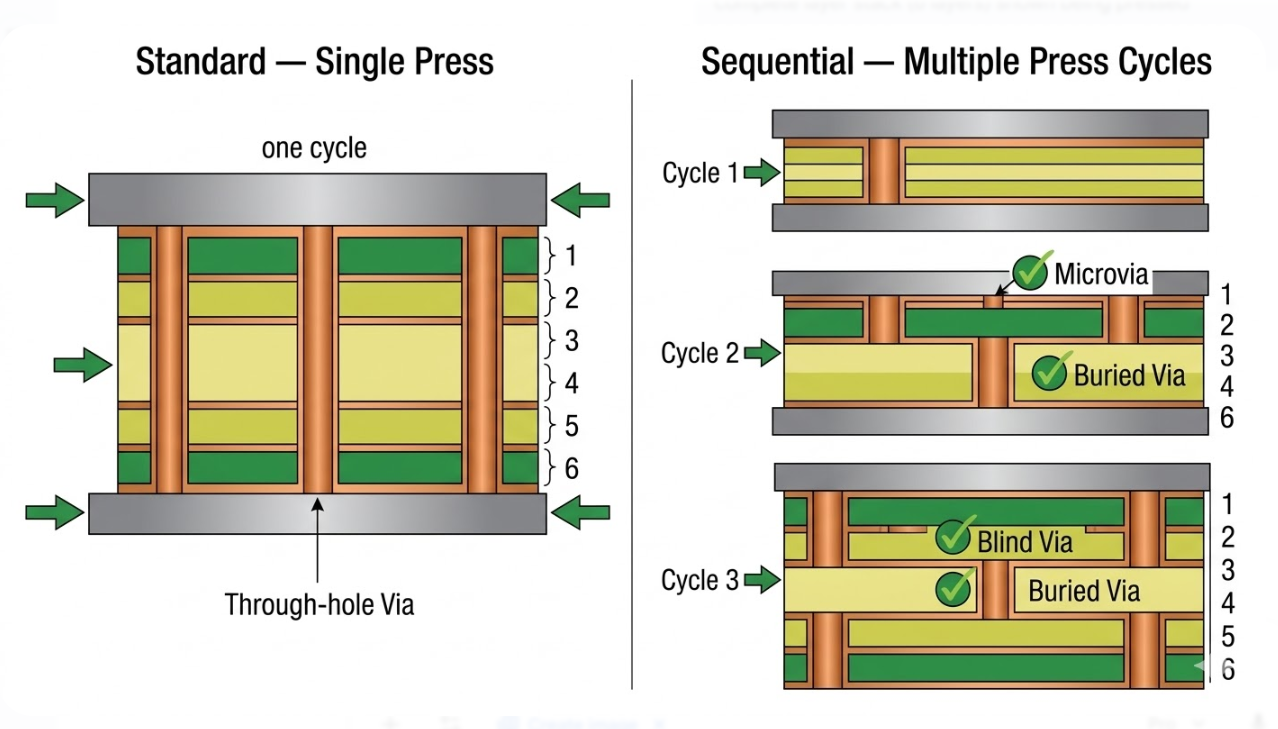
HDI 빌드업 구성은 업계에서 X+N+X 표기법으로 논의됩니다. 2+N+2 스택업은 한쪽에 2개의 빌드업 레이어와 다른 쪽에 2개의 레이어를 의미합니다. HDI 설계 표준(IPC-2226)은 6가지 유형의 HDI를 정의합니다. 타입 I과 II는 수정된 일반 공정으로 구현될 수 있지만, 타입 III에서 VI까지는 스택드 및 스태거드 마이크로비아 설계로 인해 순차 적층이 필요합니다. 압착 사이클은 약 180~200°C의 온도, 250~400PSI의 압력, 50mbar 미만의 진공에서 약 2~4시간의 제조 시간을 소요합니다.
고밀도 인터커넥트(HDI) 보드에 필수적인 이유
HDI 보드는 0.75:1에서 1:1 종횡비의 마이크로비아를 기반으로 하며, 이는 각 적층 단계 후 드릴링과 도금을 수행해야만 달성할 수 있습니다. 볼 피치 0.4mm의 현대 애플리케이션 프로세서 BGA를 생각해 보세요. 기존 관통 홀 비아로 해당 신호를 라우팅하는 것은 기하학적으로 불가능합니다. 비아인패드 마이크로비아를 사용한 순차 적층은 각 BGA 패드를 채워진 마이크로비아 바로 위에 배치하여 신호가 50~75마이크론 수준의 트레이스 폭으로 깔끔하게 내층으로 내려갑니다. 가장 고급 형태는 모든 레이어 인터커넥트(ELIC)로, 모든 레이어가 적층될 때까지 쌍으로 적층합니다. 스마트폰은 전 세계 HDI PCB 생산량의 약 50~60%를 소비하며, 메인 보드는 2+N+2 또는 3+N+3 설계로 제조됩니다.
순차 적층 공정 단계별 설명
레이어 빌드업, 드릴링, 도금 사이클
순차 적층 공정은 정밀하고 반복적인 순서를 따릅니다. 전형적인 HDI 제조 흐름이 처음부터 끝까지 어떻게 작동하는지 살펴보겠습니다.
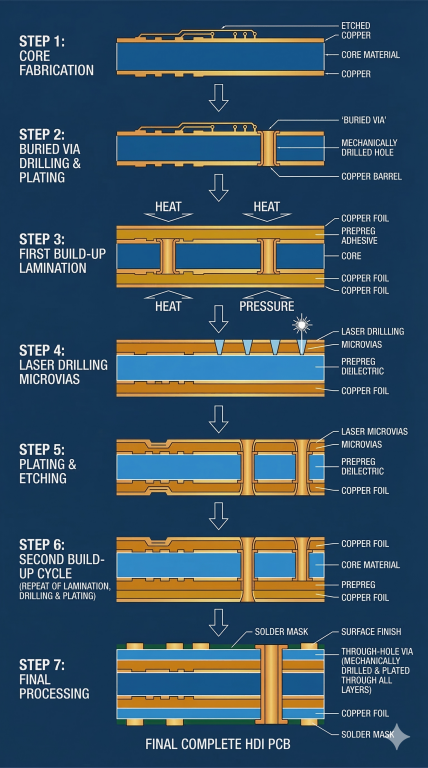
- 코어 제조: 양면 코어를 이미징, 에칭, 스트리핑하고 AOI 검사를 수행합니다.
- 코어 드릴링 및 도금: 내층을 연결하는 매립 비아의 경우, 기계적으로 드릴하고 전기 도금한 후 빌드업 레이어를 추가합니다.
- 첫 번째 빌드업 적층: 진공(50mbar 미만), 열(180~185°C), 압력(250~400PSI) 하에서 프리프레그와 구리 박을 코어 양면에 압착합니다.
- 마이크로비아 레이저 드릴링: UV 레이저(355nm)로 100마이크론 미만의 마이크로비아를 드릴하고, CO2 레이저로 100~150마이크론 마이크로비아를 처리합니다.
- 디스미어 및 도금: 과망간산염 또는 플라즈마로 벽면을 처리하여 수지 잔류물을 제거하고, 무전해 구리로 시드 처리한 후 최소 20~25µm 두께로 전해 도금합니다.
- 이미징 및 에칭: 레이저 다이렉트 이미징(LDI)을 사용하여 빌드업 레이어에 회로 패턴을 형성한 후 패턴을 에칭합니다.
- 추가 빌드업 레이어 반복: 각 추가 빌드업 레이어마다 3~6단계를 반복합니다. 3+N+3 보드는 이 순서를 각 면에서 세 번 통과합니다.
- 최종 처리: 마지막 단계로 관통 홀을 드릴하고, 표면 마감, 솔더 마스크, 실크스크린을 적용하며, 100% 전기 테스트를 수행하여 보드를 완성합니다.
정밀도를 위한 소재 선택 및 압착 파라미터
라미네이트가 여러 번의 열 사이클을 견뎌야 하므로 소재 선택이 중요합니다. 설계자는 Tg 170~180°C, Td 340°C 이상의 FR-4 등급을 선택해야 합니다. Z축 CTE는 반복 압착 및 리플로우 시 마이크로비아의 스트레스를 최소화하기 위해 3.5% 미만이어야 합니다. 고속 응용 분야에서는 파나소닉 Megtron 6(Dk ~3.4, Df ~0.002)과 같은 저Dk/Df 소재가 표준 FR-4(Dk 4.2~4.5, Df 0.017~0.025)에 비해 신호 손실을 크게 줄입니다.
| 파라미터 | 표준 FR-4 | 고Tg FR-4 | Megtron 6 |
| Dk (1GHz) | 4.2~4.5 | 4.2~4.5 | ~3.4 |
| Df (1GHz) | 0.017~0.025 | 0.015~0.020 | ~0.002 |
| Tg (°C) | 130~140 | 170~180 | 185 이상 |
| Td (°C) | 310~340 | 340~350 | 410 이상 |
고성능 HDI 설계의 주요 이점
더 높은 배선 밀도와 소형화
250~350마이크론의 마이크로비아 패드는 500~700마이크론의 관통 홀 비아보다 훨씬 적은 공간을 차지합니다. 비아인패드 설계는 BGA 패드의 팬아웃 트레이스를 사실상 없애는데, 이는 현재 프로세서와 FPGA가 패키징되는 0.4~0.5mm 피치 패키지에서 매우 중요합니다. 비아인패드 없이는 많은 미세 피치 패키지를 실용적인 보드 크기에서 라우팅하는 것이 불가능합니다.
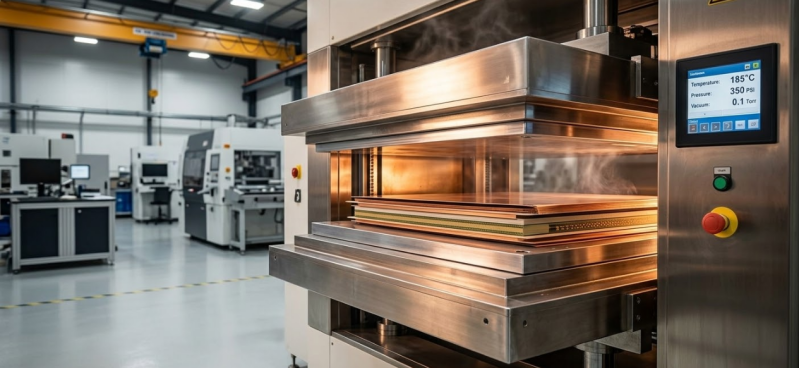
레이어 수 절감 효과는 실질적입니다. 관통 홀 방식의 12레이어 설계를 HDI 마이크로비아로 전환하면 일반적으로 8레이어로 줄일 수 있습니다. 스마트폰의 일반적인 메인 보드는 2+N+2 또는 3+N+3 스택업으로 8~12레이어를 사용하며, 빌드업 레이어에서 50/50마이크론 라인/스페이스를 구현합니다. 이는 일반 보드의 두 배 수준입니다.
순차 적층의 주요 밀도 이점:
- 마이크로비아 패드(250~350마이크론) 대 관통 홀 패드(500~700마이크론), BGA 패드 사이에 2~3배 더 많은 배선 채널 확보.
- 비아인패드로 팬아웃 배선 제거, 0.4~0.5mm 피치 BGA에 필수적.
- 동등한 관통 홀 설계 대비 레이어 수 30~50% 감소.
- 보드 면적 30~60% 감소, 공간이 제한된 응용 분야에서 결정적인 이점.
- 미세 트레이스 구현: 빌드업 레이어에서 50/50마이크론 라인/스페이스, 표준 레이어의 100/100마이크론 대비.
향상된 신호 무결성과 열 관리
순차 적층은 실질적이고 측정 가능한 신호 무결성 개선을 제공합니다. 표준 보드의 관통 홀 비아는 미사용 레이어를 지나는 스텁을 만들어 고주파에서 공진합니다. 1mm 길이의 작은 스텁도 약 37.5GHz에서 공진하기 시작하여 훨씬 낮은 주파수에서 신호에 영향을 미칩니다. 반면 블라인드 마이크로비아는 필요한 레이어만 연결하므로 스텁이 완전히 제거됩니다. 마이크로비아의 기생 성분은 크게 낮습니다: 커패시턴스 0.02~0.05pF, 인덕턴스 0.05~0.1nH로, 관통 홀 비아의 0.3~0.7pF 및 0.3~1.0nH와 비교됩니다. 이로 인해 표준 다층 대비 임피던스 허용 오차가 5~10% 낮아집니다.
| 파라미터 | 관통 홀 비아 | 마이크로비아 (HDI) |
| 기생 커패시턴스 | 0.3~0.7pF | 0.02~0.05pF |
| 기생 인덕턴스 | 0.3~1.0nH | 0.05~0.1nH |
| 임피던스 허용 오차 | ±10~15% | ±5~10% |
| 스텁 공진 위험 | 5GHz 이상에서 현저히 존재 | 완전 제거 |
순차 적층은 열 관리에도 이점을 제공합니다. 더 연속적인 그라운드 및 전원 플레인으로 그라운드 바운스와 EMI가 감소합니다. 고온 부품 바로 아래에 열 마이크로비아를 조밀하게 배치하면 성긴 관통 홀 열 비아 패턴 대비 열저항을 30~50% 줄일 수 있습니다.
제조 과제와 전문적 해결책
정렬 정확도 및 레지스트레이션 제어
우선, 각 압착 사이클마다 정렬 불량이 발생할 수 있습니다. 4~6 사이클을 거치면 미세한 레지스트레이션 오차도 누적될 수 있으며, HDI 허용 오차가 표준 ±25~50마이크론으로 엄격하여 여유가 거의 없습니다. IPC-6012E Class 3은 ±50마이크론을 규정하여 여러 사이클에 걸쳐 여유가 거의 없습니다.
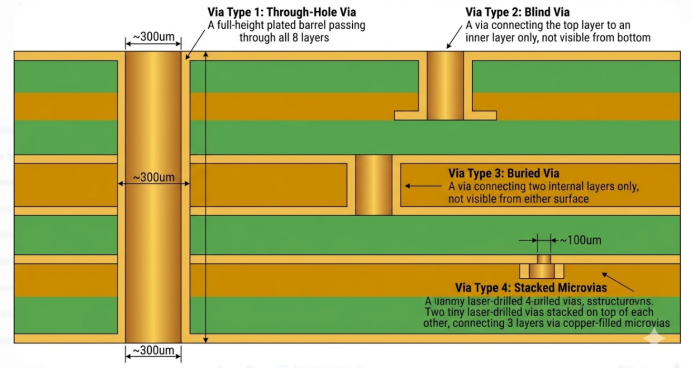
제조업체들은 X선 정렬 시스템(±10~15마이크론 정확도)과 LDI 시스템(±5~10마이크론)으로 이를 해결합니다. 라미네이트는 사이클당 축당 0.02~0.05% 수축하므로, 각 소재 및 스택업 구성에 대해 측정된 수축 데이터를 기반으로 아트웍 사전 스케일링이 필요합니다.
박리 방지 및 균일한 두께 보장
PCB 제작자들에게 가장 골칫거리는 박리입니다. 압착 사이클은 접합선에 열 스트레스를 가하며, 수분 흡수, 불완전한 경화, 표면 오염, 모든 압착으로 인한 열이 문제가 됩니다. 그래서 소재를 50% RH 미만에서 보관하고 105~120°C에서 수 시간 예비 건조합니다. 수분은 0.15% 미만으로 유지해야 합니다. 구리 결합 처리는 IPC-6012E Class 3의 최소 기준인 0.7N/mm를 훨씬 상회하는 1.0N/mm 이상의 박리 강도를 목표로 합니다. 열 신뢰성은 288°C에서 각 10초씩 6번의 솔더 플로트 사이클로 검증됩니다. Td는 340°C를 초과해야 하며, 유전체 두께 허용 오차는 ±10~15%로 유지됩니다.
순차 적층에서의 JLCPCB 전문성
고급 다단계 압착 및 레이저 드릴링 역량
전자 과정에서 HDI 보드를 공부하면서, JLCPCB가 복잡한 작업을 수행하는 방식이 상당히 인상적이었습니다. 온도와 압력을 단계적으로 조절하는 진공 적층 프레스를 사용하여 경화가 균일하게 이루어지고 유전체 두께가 일정하게 유지됩니다. 또한 100마이크론 크기의 마이크로비아를 뚫을 수 있는 UV 및 CO2 레이저 드릴링 장비를 보유하고 있어, 보드에 더 많은 것을 집약하는 데 매우 중요합니다.
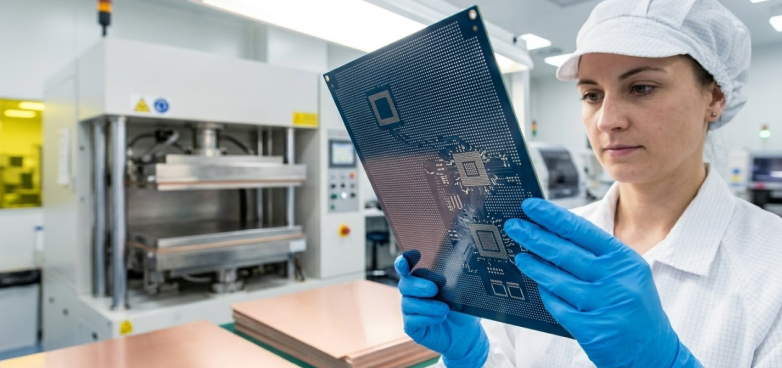
이 시설은 3+N+3까지의 빌드업 구성을 처리할 수 있으며, 스택드 또는 스태거드 오프셋 등 다양한 레이어 배치를 구현할 수 있습니다. IPC-2226 스택업 규격이 많이 논의되고 있는데, 실제 현장에서 필요한 경우 구리 충전까지 포함하여 스택드, 스태거드 마이크로비아 등 모든 변형을 구현하는 것을 보면 매우 인상적입니다.
신뢰할 수 있는 HDI 생산을 위한 엄격한 품질 관리
각 이미징 및 에칭 공정 후, 다음 레이어로 덮이기 전에 10~20마이크론 해상도로 결함을 포착하는 AOI를 거칩니다. 이후 X선 검사를 통해 정렬 상태와 마이크로비아 품질이 요건을 충족하는지 확인합니다. 더 철저하게 검증하기 위해 테스트 쿠폰을 마이크로 단면 분석하여 구리 두께, 유전체 균일성, 결합 무결성을 확인합니다.
완성된 모든 보드는 100% 전기 테스트를 받으며, TDR 임피던스 테스트를 사용하여 제어 임피던스 트레이스가 ±5~10% 내에 유지되는지 확인합니다. 이 제조소는 ISO 9001 인증을 받고 UL 제조업체로 등재되어 있으며, IPC Class 2 및 Class 3 생산 기준을 통과합니다. 즉, 이 공정이 업계의 모든 주요 기관에 의해 검증되었다는 것을 확신할 수 있습니다.
프로토타입에서 대량 생산까지 확장 가능한 솔루션
프로토타입을 제작할 때는 최소 5개부터 시작할 수 있습니다. 설계가 완성되면 완전한 대량 생산으로 증산할 준비가 됩니다. 온라인 즉시 견적 도구를 통해 모든 HDI 스택업의 대략적인 가격을 확인할 수 있으며, DFM 검토를 통해 마이크로비아 종횡비나 레지스트레이션 허용 오차처럼 설계 후에 맞닥뜨릴 수 있는 제조 가능성 문제를 미리 파악할 수 있습니다. HASL, ENIG, OSP, 이멀젼 실버, 이멀젼 틴 등 다양한 표면 마감도 제공합니다. 필요에 가장 적합한 것을 선택할 수 있습니다.
설계가 한계를 밀어붙이고 있고 표준 PCB 이상이 필요하다면, JLCPCB에서 순차 적층이 답입니다. 순차 적층은 현대 HDI PCB의 존재를 가능하게 하는 방법 그 자체입니다. 보드를 단계적으로 적층하고 각 압착 사이클 사이에 드릴링과 도금을 수행합니다. 그것이 프로젝트에 필요한 마이크로비아, 블라인드 및 매립 비아, 비아인패드, 미세 트레이스 형상을 가능하게 합니다. 단순 적층보다 조금 더 어렵고 확실히 더 비싸지만, 더 적은 레이어, 더 작은 보드, 우수한 전기 성능이라는 이점은 첨단 기술 설계에서 없어서는 안 될 요소입니다.
자주 묻는 질문 (FAQ)
Q1: PCB 제조에서 순차 적층이란 무엇인가요?
순차 적층은 각 압착 사이클 사이에 드릴링과 도금을 수행하며 PCB를 레이어별로 쌓아 올리는 다중 사이클 제조 기법입니다.
Q2: 일반적인 HDI PCB에는 몇 번의 적층 사이클이 필요한가요?
사이클 수는 빌드업 구성에 따라 다릅니다. 1+N+1 설계는 면당 1회 추가 적층(총 2회 추가), 2+N+2는 면당 2회, 3+N+3는 면당 3회가 필요합니다.
Q3: 스택드 마이크로비아와 스태거드 마이크로비아의 차이점은 무엇인가요?
스택드 마이크로비아는 여러 빌드업 레이어에 걸쳐 서로 바로 위에 위치하며, 그 위에 다음 비아를 위한 견고한 랜딩 패드를 제공하기 위해 하위 비아에 구리 충전이 필요합니다. 스태거드 마이크로비아는 연속 레이어에서 오프셋으로 배치되어 직접 쌓이는 것이 아닌 중간 구리 패드를 통해 연결됩니다.
Q4: 순차 적층이 표준 PCB 제조보다 왜 더 비싼가요?
비용 증가는 여러 요인에서 비롯됩니다: 추가 압착 사이클(각 2~4시간 추가), 레이저 드릴링 장비 및 시간, 추가 이미징 및 도금 단계, 더 엄격한 레지스트레이션 요구사항, 각 단계에서의 집중적인 검사. 각 순차 사이클은 제조 비용을 약 15~30% 추가합니다.
Q5: HDI PCB의 순차 적층에 가장 적합한 소재는 무엇인가요?
유리 전이 온도 150~180°C, 분해 온도 340°C 이상의 중간~고Tg FR-4가 표준 선택입니다. 고속 설계에는 파나소닉 Megtron 6(Dk 3.4, Df 0.002)이나 Isola IS415 같은 저손실 소재가 선호됩니다.
지속적인 성장
CTE 불일치 스트레스 감소: 더 신뢰할 수 있는 PCB를 위한 실용적인 방법
핵심 요약 CTE 불일치(FR4의 높은 Z축 CTE 대 구리)는 무연 리플로우 및 열 사이클링 하에서 더욱 악화되는 PCB 휨, 비아 균열, 층간 박리, 솔더 피로를 유발하는 열응력을 만들어냅니다. 대칭 스택업과 균형 잡힌 구리 배분, 고Tg/저CTE 재료, 엄격한 공정 제어(적층, 냉각, 수분, 일관된 비아 도금)로 완화하세요. 표준 FR4의 Z축 열팽창계수가 최대 70 ppm/°C에 달하는 반면 구리는 17 ppm/°C에 불과하다는 것을 알고 계셨나요? 보드가 가열될 때 이 두 재료의 팽창은 4배나 차이가 납니다. CTE 불일치라고 불리는 이 차이가 인쇄 회로 기판의 휨, 솔더 조인트 균열, 층간 박리의 가장 빈번한 근본 원인 중 하나입니다. 리플로우 후 구부러진 PCB나 도금 관통홀의 불가사의한 배럴 균열을 경험하셨다면 CTE 불일치가 원인이었을 가능성이 높습니다. 더 얇은 보드, 더 작은 부품, 더 높은 무연 리플로우 온도로 인해 이 열팽창 차이를 관리하는 것은 그 어느 때보다 중요한 ......
UL94 V0이 안전한 PCB 제조에 중요한 이유
핵심 요약 UL94 V0는 PCB 재료의 최고 난연 등급으로, 불꽃 방울 없이 10초 이내 자기 소화를 요구합니다. 화재 위험을 크게 줄이며 소비자, 산업, 자동차, 의료 분야에서 안전하고 신뢰할 수 있는 PCB의 사실상 표준이 되었습니다. JLCPCB는 기본적으로 UL94 V0 규정 준수 FR4 및 고Tg 재료를 제공하여 성능이나 예산을 희생하지 않고 규제 준수(UL, CE, CCC)와 장기적인 신뢰성을 보장합니다. 소폭의 비용 절감을 위해 V0 등급을 희생하지 마세요. 거의 모든 회로 기판 앞면에 있는 작은 인쇄 문자를 본 적이 있으신가요? 바로 노트북, 휴대폰 충전기, LED 드라이버 내부의 보드 말입니다. 그 작은 마크가 전자제품 생산에서 가장 중요한 안전 등급 중 하나입니다. UL94 V0는 Underwriters Laboratories가 발표한 난연성 표준으로, PCB 기판 재료가 화염 원천이 제거된 후 10초 이내에 자기 소화됨을 알려줍니다. 왜 신경 써야 할까요? UL, CE, ......
안전한 PCB를 위한 올바른 UL94 등급 선택 방법
핵심 요약 이 글은 PCB 화재 안전 및 규정 준수를 위한 올바른 UL94 등급 선택 방법을 설명합니다: V-0는 대부분의 전자제품의 일반적인 기준이며, V-1/HB는 주로 규제가 덜한 용도에 사용됩니다. 또한 등급 성능이 재료 선택, 두께, 공정 제어에 달려 있다고 강조하므로, UL 인증 라미네이트와 추적 가능한 UL 인증 제조업체를 이용하세요. 단 하나의 PCB 화재가 유독 가스를 발생시키고 전체 제품을 소멸시키며 회사를 심각한 법적 위험에 빠뜨릴 수 있다는 것을 들어본 적 있으신가요? 바로 이것이 UL94 등급이 존재하는 이유입니다. 플라스틱 및 폴리머 재료의 가장 잘 알려진 난연성 분류 시스템으로, 인쇄 회로 기판을 최대한 안전하게 만드는 핵심 요소입니다. 간단한 LED 드라이버를 설계하든 복잡한 자동차 제어 모듈을 설계하든, PCB 기판의 난연성은 무시할 수 없습니다. 북미, 유럽, 아시아의 규제 기관들은 제품이 판매될 수 있으려면 특정 UL94 화염 등급을 요구합니다. 이 규정을 무......
유리전이온도가 PCB 신뢰성의 핵심인 이유
갓 리플로우를 마친 PCB 묶음을 오븐에서 꺼냈는데 층간 박리 물집이나 배럴 비아 균열이 발견된 경험이 있으신가요? 그런 경우라면 원인이 리플로우 프로파일이나 솔더 페이스트가 아닐 수 있습니다. 보드를 구성하는 기판 재료에 문제가 있을 수 있습니다. PCB 라미네이트의 물성 중 제조 공정을 통과하여 현장에서 사용되기까지 결정적인 차이를 만드는 가장 중요하면서도 자주 간과되는 특성이 바로 라미네이트의 유리전이온도입니다. PCB 생산에 사용되는 모든 수지 시스템은 특정 온도 이하에서 단단하고 유리 같은 물질처럼 작동합니다. 그 한계를 넘으면 수지가 부드러워지고 팽창률이 급격히 상승하며 기계적 강도가 저하되기 시작합니다. 그 온도가 바로 유리전이온도로, 보통 Tg로 표기합니다. 업계가 무연 솔더링으로 전환하고 최고 리플로우 온도가 250~260°C에 달하는 지금, Tg에 대한 지식은 더 이상 선택 사항이 아닙니다. 양질의 보드를 원하는 모든 엔지니어에게 필수 지식입니다. 이 글에서는 유리전이온도가 ......
전문 PCB 제조에서 네일 베드 테스트의 이점
제조업체들이 어떻게 매일 수천 개의 PCB를 테스트하면서도 생산 라인을 느리게 만들지 않는지 궁금한 적이 있으신가요? 그 답은 네일 베드 테스트 장비라는 얼핏 보기엔 단순해 보이는 기기에 있는 경우가 많습니다. 이 플랫폼에는 수백 개의 소형 스프링 핀이 장착되어 있으며, 각각의 핀이 회로 기판의 특정 테스트 포인트에 매우 정밀하게 닿도록 정렬되어 있습니다. 보드가 공장 라인을 벗어나기도 전에 몇 초 만에 전체 PCB의 전기적 무결성, 단락, 개방 회로, 부품 결함을 검사할 수 있습니다. 어느 정도 수량으로 PCB를 제조하고 있다면 테스트는 선택이 아닙니다. 신뢰할 수 있는 제품 납품과 품질 보증 반품의 차이입니다. 네일 베드 테스트는 수십 년 전부터 전문 PCB 제조의 핵심 요소였으며, 플라잉 프로브와 같은 최신 테스트 방법이 보편화되었지만 대량 생산에서는 여전히 금본위를 유지하고 있습니다. 속도, 반복성, 결함 커버리지 측면에서 처리량이 중요한 상황에서는 대체하기 거의 불가능합니다. 오늘은 ......
고속 PCB 우수성을 위한 마이크로스트립 라인 설계 기법
PCB의 외부 레이어에 고속 신호를 라우팅하면서 선택한 트레이스의 형상이 멀티 기가비트 데이터 레이트에서 실제로 작동할지 궁금해 본 적이 있으신가요? 분명 혼자만이 아닙니다. PCB 설계에서 가장 일반적으로 사용되는 전송 선로 구조는 마이크로스트립 라인이지만, 이 라인은 형상, 재료, 제조 공차에 매우 민감합니다. 깨끗한 아이 다이어그램과 신호 무결성 악몽의 차이는 마이크로스트립 라인 설계가 올바르게 이루어졌는지에 달려 있습니다. 2.4GHz RF 프론트엔드를 설계하든, PCIe Gen4 인터페이스든, 고속 ADC 데이터 패스든 마이크로스트립 라인은 핵심 도구입니다. 외부 레이어에서 접근이 가능하다는 점이 대부분의 설계자가 기본으로 선택하는 이유이지만, 방사, 손실, 환경 민감성에 있어 신중한 공학적 검토가 필요한 트레이드오프가 있습니다. 물리학은 다소 복잡하지만 핵심은 전기장 분포의 균형을 맞추고 실제 보드의 기생 요소에 대한 신호 내구성을 극대화하는 것입니다. 이제 기본적인 전자기 물리학과......
