Tipos de encapsulados BGA: diferencias, aplicaciones y guía de selección
13 min
- Comparación rápida de tipos de encapsulados BGA
- Explicación de los tipos de encapsulados BGA
- Cómo elegir el encapsulado BGA adecuado para diseños PCB de alta velocidad y alta fiabilidad
- Estructura del encapsulado BGA y parámetros clave
- Conclusión
- Preguntas frecuentes sobre BGA
Si está buscando los tipos de encapsulados BGA, probablemente esté intentando comprender cuál se adapta mejor a su diseño de PCB, requisitos de rendimiento o necesidades de fabricación. Con opciones como PBGA, CBGA y FBGA, cada encapsulado presenta diferentes compromisos en cuanto a rendimiento térmico, coste y fiabilidad. Elegir el tipo incorrecto puede provocar dificultades de enrutamiento, defectos de ensamblaje o incluso fallos del producto.
En esta guía, desglosamos todos los principales tipos de encapsulados BGA (BGA package), comparamos sus diferencias clave y explicamos cómo seleccionar el más adecuado para su aplicación, para que pueda diseñar con confianza y evitar errores costosos.

Figura: Vista macro de un encapsulado Ball Grid Array (BGA) montado sobre una PCB de interconexión de alta densidad.
Comparación rápida de tipos de encapsulados BGA
Tipo de |
Rango de paso de bolas |
Material del sustrato |
Aplicaciones típicas |
Rendimiento térmico |
|---|---|---|---|---|
Plastic Ball Grid Array (PBGA) |
1,27mm - 1,0mm |
Resina BT, FR-4 |
Electrónica de consumo, MCUs |
Moderado |
Ceramic Ball Grid Array (CBGA) |
1,27mm |
Cerámica |
Aeroespacial, militar |
Excelente |
Tape Ball Grid Array (TBGA) |
0,8mm - 0,5mm |
Cinta de poliimida |
Dispositivos móviles |
Bueno |
Flip-Chip Ball Grid Array (FCBGA) |
1,27mm - 0,8mm |
Laminado orgánico |
Procesadores de alto rendimiento |
Superior |
Micro BGA |
0,65mm - 0,4mm |
Orgánico delgado |
IoT, wearables, sensores |
Moderado |
Encapsulados BGA con mejora térmica |
1,27mm - 1,0mm |
Orgánico + disipador térmico |
Amplificadores de potencia, FPGA de alta gama |
Excelente |
Metal Ball Grid Array (MBGA) |
1,27mm - 1,0mm |
Metal (Aluminio) |
Motores industriales, amplificadores |
Excelente (θJA: <15℃/W) |
Explicación de los tipos de encapsulados BGA
#1 matriz de rejilla de bolas (Plastic Ball Grid Array, PBGA)
Composición del sustrato: PBGA utiliza un sustrato fabricado con resina BT (Bismaleimida Triazina). La elección de esta resina frente al FR-4 estándar se debe a su mayor temperatura de transición vítrea (Tg ≈ 180℃) y menor absorción de humedad.
Limitaciones termomecánicas: El principal modo de fallo en los PBGA es la deformación por cizalladura en las uniones de soldadura. Esto se debe a la diferencia en el coeficiente de expansión térmica (CTE) entre el chip de silicio (2,6 ppm/℃) y el sustrato laminado orgánico (≈ 13-17 ppm/℃).
Sensibilidad a la humedad: Los PBGA son propensos a absorber humedad. Según la norma J-STD-020, suelen clasificarse en MSL 3 y MSL 4. Si se supera el tiempo de exposición permitido, deben hornearse a 125℃ antes de su uso para evitar el fenómeno de "popcorning", un problema grave de delaminación causado por la rápida expansión del vapor de agua durante el reflow.
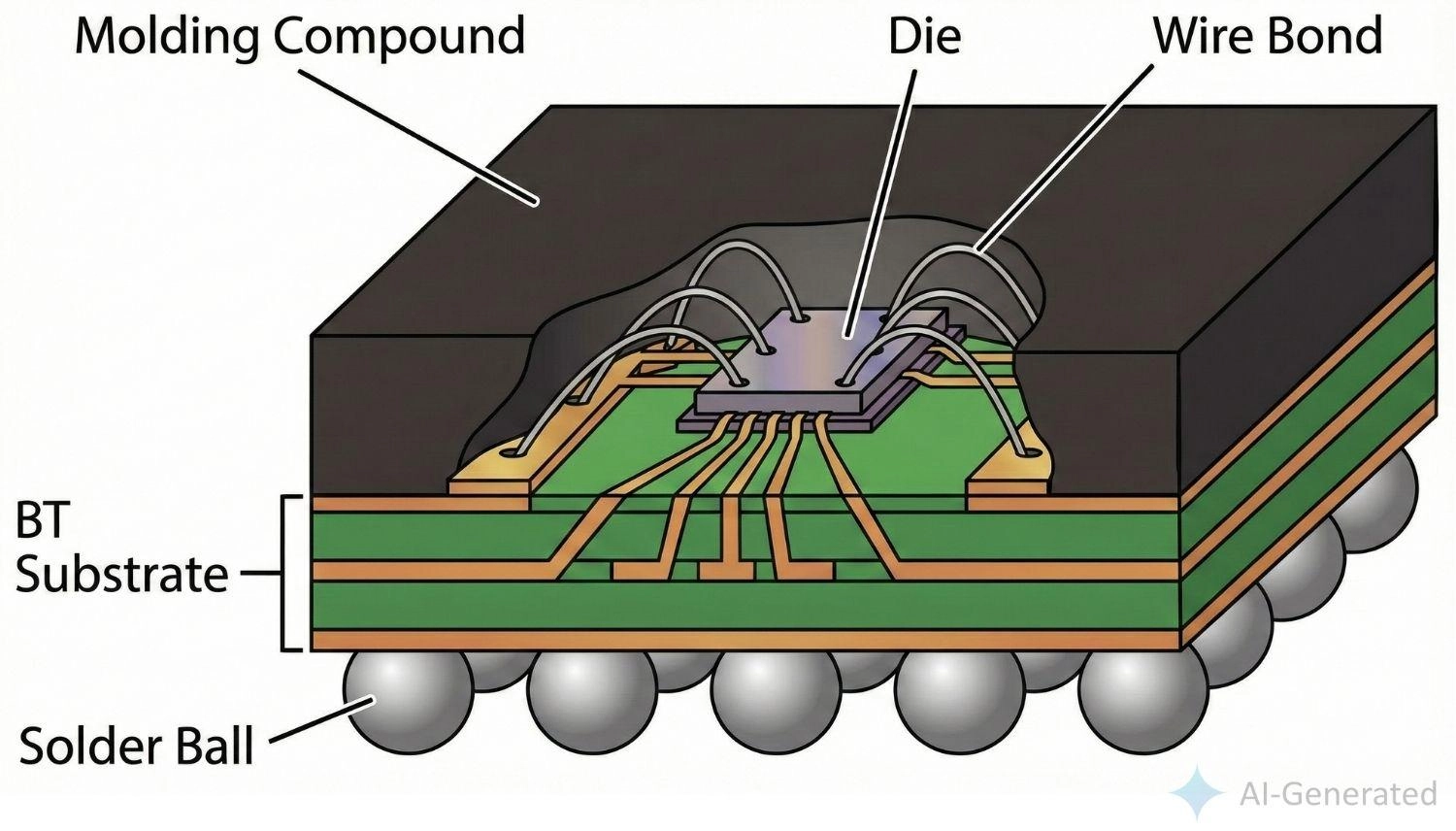
Figura: Estructura de PBGA que muestra el wire bonding y las capas de sustrato de resina BT.
Nota
¿Necesita componentes PBGA específicos para su PCBA? Consulte la disponibilidad en la biblioteca de componentes de JLCPCB.
#2 Matriz de Rejilla de Bolas de Cerámica (Ceramic Ball Grid Array, CBGA)
En aplicaciones donde la fiabilidad es imprescindible, incluso en entornos extremos (aeroespacial, telecomunicaciones), los encapsulados Ceramic Ball Grid Array (CBGA) son la opción preferida.
Sustrato: Utiliza un sustrato cerámico multicapa co-sinterizado (Al2O3).
Compatibilidad de CTE: El sustrato cerámico (CTE ≈ 6,7 ppm/℃) está casi perfectamente adaptado al chip de silicio. Esto reduce significativamente el estrés en la interfaz de unión del chip; sin embargo, dicho estrés se transfiere a las uniones de soldadura entre el encapsulado y la PCB.
Bolas "no colapsables": A diferencia de los PBGA, los CBGA suelen emplear bolas de soldadura de alta temperatura (90Pb/10Sn) unidas al encapsulado con soldadura eutéctica. Durante el reflow SMT estándar (perfil SAC305), la esfera principal no se funde; solo lo hace la interfaz eutéctica, manteniendo una altura de separación constante.
#3 Matriz de Rejilla de Bolas con Flip-Chip (Flip-Chip Ball Grid Array, FCBGA)
En computación de alto rendimiento (CPU, GPU, ASIC), las uniones por hilo introducen una inductancia inaceptable. El Flip-Chip BGA (FCBGA) sustituye los hilos por bumps C4 (Controlled Collapse Chip Connection).
Reducción de inductancia: Un wire bond típico introduce entre 2 y 3 nH de inductancia parasitaria. Los bumps C4 reducen este valor a <0,2 nH, lo cual es esencial para líneas SerDes de alta velocidad (>10 Gbps).
Red de distribución de potencia (PDN): La trayectoria vertical proporciona una menor impedancia (ZPDN), lo que ayuda significativamente a reducir la caída de tensión (Vdroop) durante conmutaciones con alto di/dt.
Física del underfill: Dado que el chip está unido rígidamente al sustrato mediante bumps, se inyecta una resina epoxi por capilaridad entre ambos. Este material está diseñado para redistribuir el estrés termomecánico y evitar la fatiga o fractura de los bumps.
Parámetro |
FCBGA |
PBGA con wire bonding |
Mejora de rendimiento |
|---|---|---|---|
Inductancia parasitaria |
0,2-0,5 nH |
2-5 nH |
Reducción de 5-10× |
Frecuencia máxima |
>5 GHz |
2-3 GHz |
Mejora >60% |
Resistencia térmica (θJC) |
0,1-0,3°C/W |
1-3°C/W |
Mejora de 5-10× |
Entrega de potencia (impedancia PDN) |
<5 mΩ |
15-30 mΩ |
Mejora de 3-6× |
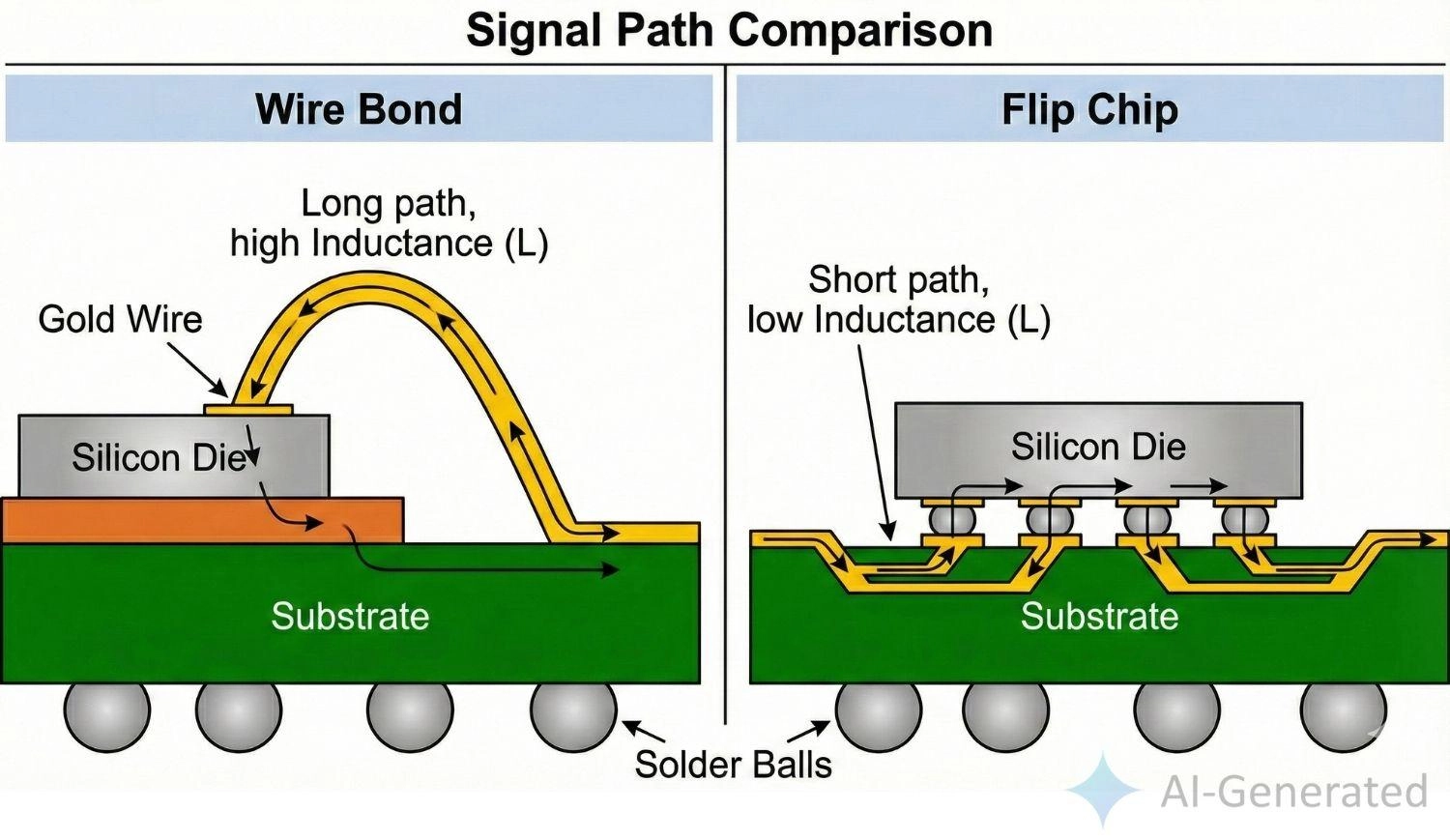
Figura: Comparación de la inductancia del camino de señal entre tecnología BGA con wire bonding y flip-chip.
#4 Matriz de Rejilla de Bolas en Cinta (Tape Ball Grid Array, TBGA)
La tecnología TBGA utiliza un sustrato flexible de cinta de poliimida con un grosor de 25 - 75 μm y capas de circuito de cobre.
Rendimiento térmico: Los TBGA suelen construirse en configuración "cavity-down", lo que permite que la parte posterior del chip esté directamente unida a un disipador térmico.
Aplicación: Ideal para dispositivos móviles de perfil delgado que requieren un número moderado de pines y buena disipación térmica.
#5 Micro BGA
Los Micro BGA (μBGA) son una forma común de encapsulado tipo Chip Scale Package (CSP), normalmente con una huella no superior a 1,2 veces el tamaño del chip. Se utilizan ampliamente en smartphones, wearables y memorias donde el espacio es crítico.
Paso extremadamente fino: El paso de bola suele reducirse a 0,5 mm hasta 0,3 mm o menos, lo que requiere una alta precisión en colocación y diseño de stencil.
Consideraciones de pasta de soldadura: En pasos inferiores a 0,4 mm, la pasta tipo 4 puede presentar limitaciones de impresión dependiendo del stencil y el control del proceso, por lo que se recomienda utilizar pasta tipo 5 o más fina.
Fiabilidad y refuerzo: Debido al pequeño volumen de soldadura y al desajuste de CTE, los μBGA son más susceptibles a fatiga térmica y mecánica. El uso de underfill (capilar o por esquinas) es habitual para mejorar la fiabilidad.
Impacto en fabricación: El paso fino y las uniones ocultas dificultan la inspección y retrabajo, requiriendo inspección por rayos X y control estricto del proceso.
#6 Encapsulados BGA con mejora térmica (ej. ePBGA)
Estos encapsulados están diseñados para aplicaciones de alta potencia (normalmente entre 5–20 W o más) donde la disipación térmica es crítica.
Construcción: Integran un disipador metálico (normalmente cobre o aluminio) dentro del encapsulado. El chip se fija directamente a esta interfaz térmica para mejorar la transferencia de calor.
Rendimiento térmico: En comparación con PBGA estándar, estos encapsulados mejoran significativamente la resistencia térmica unión-carcasa (θJC) y la disipación global.
Nota de diseño PCB: Para aprovechar estas ventajas, se deben utilizar vías térmicas densas (via-in-pad, rellenas o tapadas) bajo el encapsulado. Una correcta distribución de cobre y diseño del stack-up es clave.
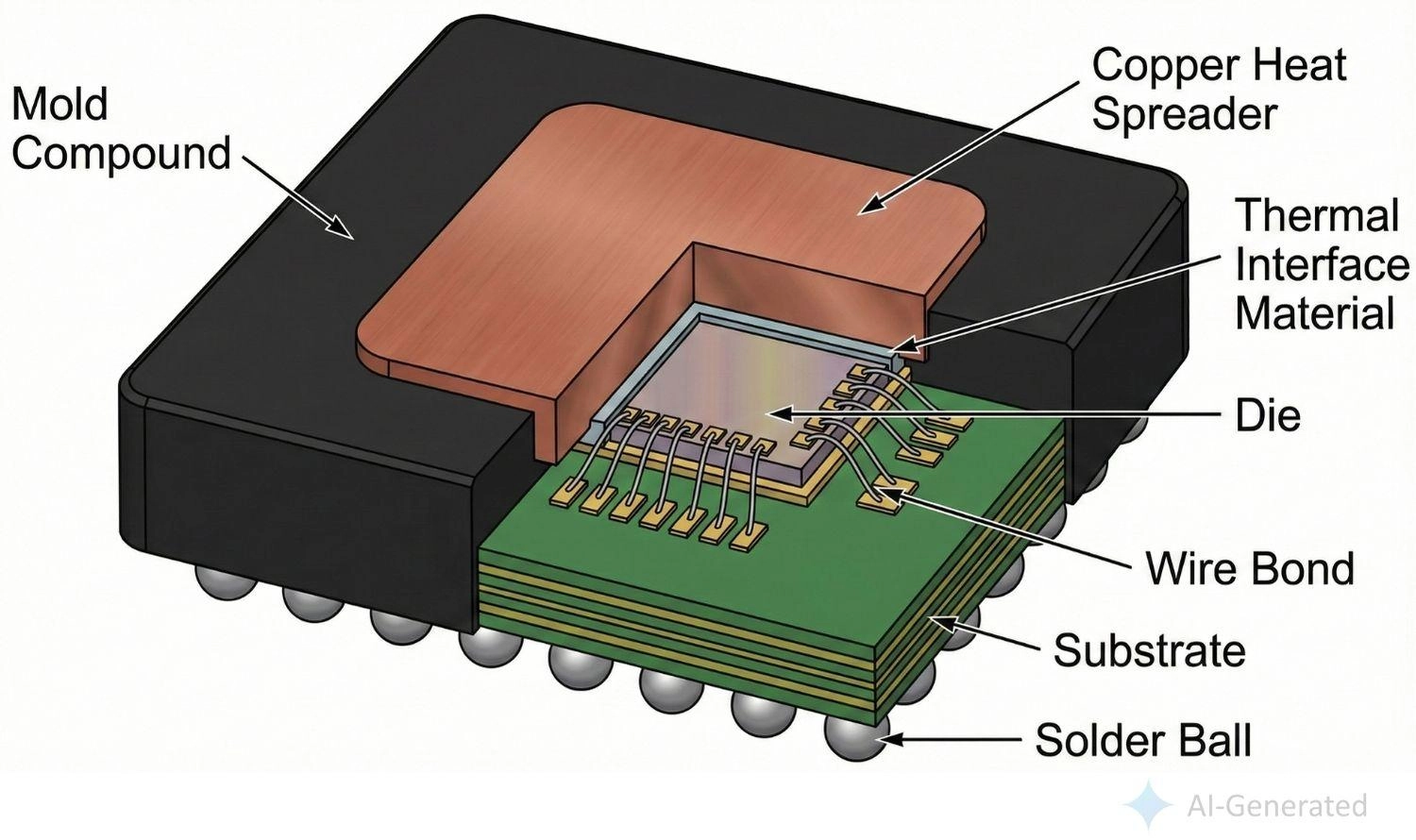
Figura: Estructura de BGA mejorado con disipador integrado.
#7 Matriz de Rejilla de Bolas Metálica (Metal Ball Grid Array, MBGA)
El Metal Ball Grid Array (MBGA) utiliza un sustrato metálico (normalmente aluminio anodizado) en lugar de los sustratos orgánicos o cerámicos estándar.
Construcción: El chip de silicio se fija al sustrato metálico mediante un adhesivo térmicamente conductor. Una capa de circuito de película fina se lamina sobre el metal para proporcionar el enrutamiento eléctrico, conectada mediante wire bonding.
Física térmica: El núcleo de aluminio actúa como un disipador de calor integrado de gran capacidad. Esto permite que el MBGA alcance un rendimiento térmico comparable al CBGA, pero a un coste significativamente inferior.
Aplicaciones: Es la opción preferida para controladores de motores industriales, amplificadores operacionales de alta potencia y tarjetas de telecomunicaciones donde la disipación térmica es el principal factor de diseño.
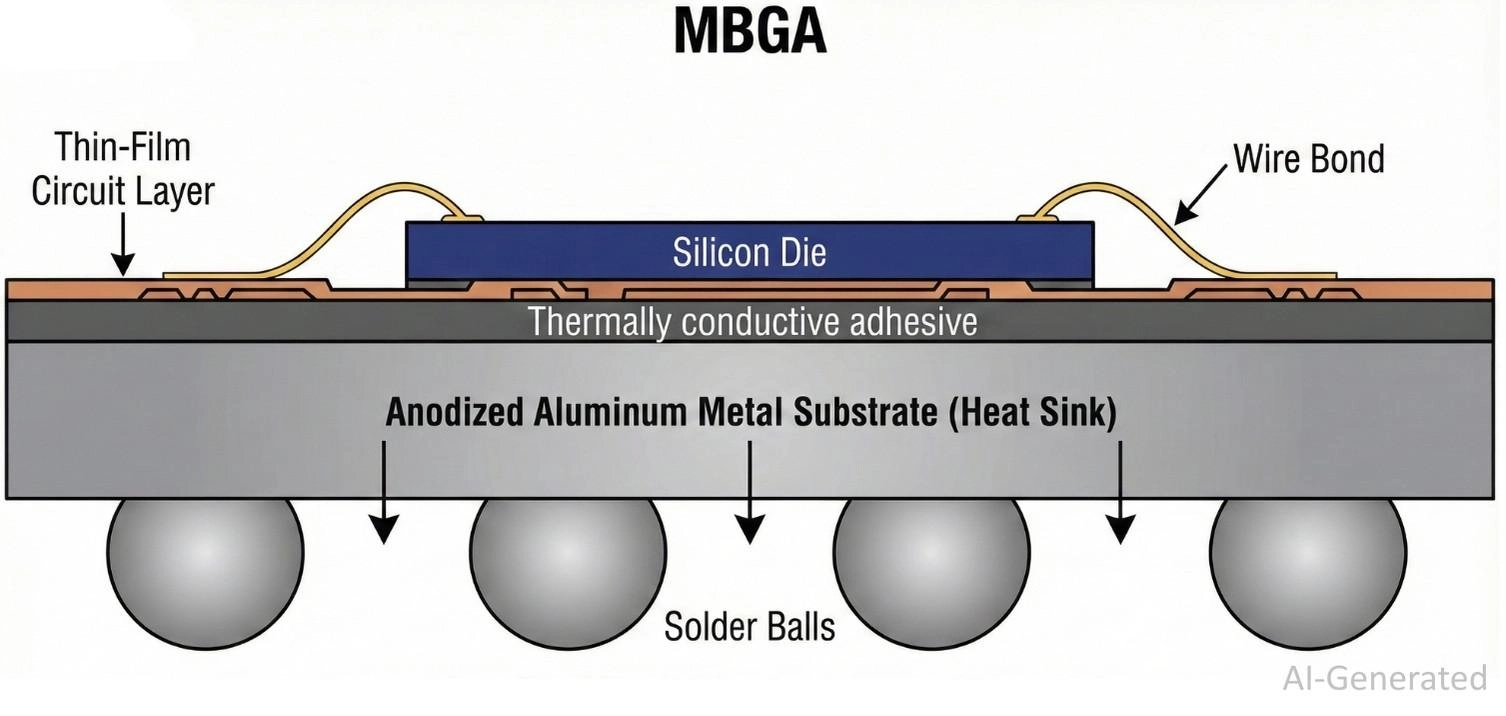
Figura: Estructura de encapsulado MBGA con sustrato de aluminio para disipación térmica.
Cómo elegir el encapsulado BGA adecuado para diseños PCB de alta velocidad y alta fiabilidad
La selección de un encapsulado BGA adecuado implica evaluar de forma sistemática los parámetros eléctricos, térmicos, mecánicos y de coste.

Si la refrigeración pasiva no puede mantener Tj < 100℃, se recomienda utilizar CBGA o variantes EBGA.
Dominio de aplicación |
BGA recomendado |
Factores clave de selección |
Nivel de coste |
|---|---|---|---|
Electrónica de consumo |
PBGA |
Rentabilidad, rendimiento adecuado |
$ |
Móviles / Wearables |
TBGA, Micro BGA |
Perfil ultrafino, paso fino |
$$ |
Computación de alto rendimiento |
FCBGA |
Máximo rendimiento eléctrico, baja impedancia PDN |
$$$ |
Aeroespacial / Militar |
CBGA, CGA |
Alta fiabilidad, compatibilidad CTE, robustez |
$$$$ |
Sensores IoT |
Micro BGA |
Miniaturización, bajo perfil |
$$ |
Electrónica de potencia |
EBGA |
Gestión térmica mejorada (>10W) |
$$$ |
Estructura del encapsulado BGA y parámetros clave
Un BGA se compone de cinco elementos principales: el sustrato (orgánico o cerámico), la zona de unión del chip, la estructura de interconexión (wire bonding o flip-chip), el material de encapsulado y la matriz de bolas de soldadura.
El sustrato actúa como soporte mecánico e interfaz eléctrica, conduciendo las señales desde el chip hacia las conexiones externas.
Los siguientes parámetros definen su rendimiento:
- Ball Pitch: La distancia entre centros de bolas puede ser de 1,5 mm en diseños antiguos, reduciéndose hasta 0,4 mm en encapsulados de paso fino.
- Material del sustrato: La resina BT ofrece mejores propiedades eléctricas, FR-4 es más económico y la cerámica proporciona la mejor conductividad térmica y compatibilidad CTE con el silicio.
- Composición de la soldadura: El SnPb eutéctico (63/37) ha sido reemplazado por alternativas sin plomo como SAC305 (96,5% estaño, 3% plata, 0,5% cobre) y SAC405, con diferentes propiedades térmicas y mecánicas.
Conclusión
No todos los encapsulados BGA son intercambiables: su elección afecta directamente a la complejidad de enrutamiento, rendimiento térmico y rendimiento de ensamblaje.
- Utilice PBGA para diseños generales sensibles al coste.
- Elija CBGA cuando la estabilidad térmica y la fiabilidad sean críticas.
- Utilice FBGA o BGA de paso fino para aplicaciones de alta densidad y alta velocidad.
Antes de finalizar su selección, verifique siempre la compatibilidad del paso de bola (ball pitch), la capacidad del stack-up de la PCB (HDI o no) y las limitaciones de ensamblaje, como el control del reflow y el acceso para inspección.
En la práctica, el “mejor” encapsulado BGA es aquel que su diseño de PCB y su proceso de fabricación pueden soportar de forma fiable, no simplemente el que ofrece el mayor rendimiento sobre el papel.
Una implementación fiable requiere un socio de fabricación que comprenda la física del proceso de reflow. Con capacidades de ensamblaje de paso de 0,35 mm, perfiles de reflow de 10 zonas e inspección por rayos X 3D al 100%, JLCPCB garantiza que sus diseños de alta densidad funcionen tal como fueron simulados.
¿Listo para prototipar? Obtenga un presupuesto instantáneo para su ensamblaje BGA de alta precisión en JLCPCB.
Preguntas frecuentes sobre BGA
P: ¿Cuál es el tipo de BGA más común?
El PBGA (Plástico) es el estándar de la industria para la mayoría de los productos electrónicos de consumo e industriales. Es altamente rentable, ofrece un excelente rendimiento eléctrico y proporciona una unión de soldadura fiable gracias a la buena compatibilidad del coeficiente de expansión térmica (CTE) con los materiales FR-4 estándar de las PCB.
Aplicaciones comunes: microprocesadores, chips de memoria (DDR) y controladores de red.
P: ¿Qué tipo de BGA ofrece el mejor rendimiento térmico?
Para aplicaciones de alta potencia, los encapsulados BGA con mejora térmica (ePBGA) y FCBGA (Flip Chip BGA) son las mejores opciones. Pueden manejar entre 5 W y más de 20 W, dependiendo del flujo de aire y del diseño de las vías térmicas de la PCB.
P: ¿Cuál es la diferencia entre PBGA y CBGA?
La diferencia principal radica en el material del sustrato:
PBGA (Plástico): utiliza un laminado basado en plástico. Es más ligero y económico, pero tiene menor conductividad térmica.
CBGA (Cerámico): utiliza un sustrato cerámico. Ofrece una fiabilidad superior en condiciones extremas de temperatura y entornos de alta frecuencia (como aeroespacial o telecomunicaciones), pero es más costoso y requiere una gestión cuidadosa del CTE para evitar grietas en las uniones de soldadura.
Artículos populares
Siga aprendiendo
Cómo elegir una placa de desarrollo ESP32: guía para principiantes
El salto desde hacer parpadear un LED sencillo hasta construir un dispositivo doméstico inteligente conectado a la nube es un hito emocionante para cualquier principiante en electrónica. En el centro de esta transición suele haber un protagonista indiscutible: el ESP32. Sin embargo, cuando busca por primera vez una placa de desarrollo ESP32, se encontrará inmediatamente con una abrumadora variedad de modelos, formatos y especificaciones. ¿Cómo saber cuál es la adecuada para su primer proyecto IoT (Int......
Tipos de encapsulados BGA: diferencias, aplicaciones y guía de selección
Si está buscando los tipos de encapsulados BGA, probablemente esté intentando comprender cuál se adapta mejor a su diseño de PCB, requisitos de rendimiento o necesidades de fabricación. Con opciones como PBGA, CBGA y FBGA, cada encapsulado presenta diferentes compromisos en cuanto a rendimiento térmico, coste y fiabilidad. Elegir el tipo incorrecto puede provocar dificultades de enrutamiento, defectos de ensamblaje o incluso fallos del producto. En esta guía, desglosamos todos los principales tipos de......
Cómo soldar componentes SMD como profesional [Actualizado 2026]
La soldadura es una habilidad fundamental que conviene dominar y, cuando se trata de SMD, todo se vuelve más complejo y de menor tamaño. La soldadura es similar a la soldadura por fusión, pero en lugar de unir dos piezas de hierro/acero, estamos uniendo componentes de pequeñas dimensiones. Para desarrollar un circuito, la mejor forma de unir dos componentes es mediante soldadura. Existen dos tipos principales de componentes en electrónica: uno es el de orificio pasante (through-hole), con patas largas......
Condensadores 101: Cuales son sus funciones y tipos
Los condensadores son componentes indispensables en el diseño de PCBs (placas de circuito impreso), ya que aportan funciones esenciales como el almacenamiento de energía, el filtrado de ruido y la regulación de tensión. Tanto si usted diseña un circuito sencillo como una placa multicapa avanzada, es crucial comprender los distintos tipos de condensadores y sus aplicaciones. La estructura básica de un condensador consiste en dos placas metálicas separadas por un dieléctrico. Existen condensadores de ti......