내층 구리 피복률이 보드 두께에 미치는 영향
Apr 22, 2026에 마지막으로 업데이트됨
PCB 제조 업계에서 가장 많이 사용되는 소재 용어 중 하나가 프리프레그(Prepreg)로, B-스테이지(B-stage) 상태라고도 부릅니다. 이 용어들은 다층 기판 사이에 위치하는 이 "접착 시트"가 적층 전 특수한 반경화 상태에 있음을 나타냅니다. 프리프레그는 고온 가압 환경에서 액체처럼 유동하여 제한된 가압 시간 내에 기판 사이의 빈 공간을 채워야 합니다. 이 과정을 "수지 충전"이라고 합니다.

위 개념에서 쉽게 유추할 수 있듯, L2 레이어의 동박 패턴 분포가 매우 희박한 경우, 고온·고압·고진공 조건에서 프리프레그가 액체 상태로 유동할 때 각 레이어 사이의 빈 공간을 채우는 방향으로 이동합니다. L2 레이어의 동박 패턴 면적이 작을수록 채워야 할 공간이 더 많아지고, 이로 인해 냉각·경화 후 프리프레그 전체 두께가 더 얇아집니다. 이러한 편차가 여러 레이어에 걸쳐 누적되면 최종 기판 두께가 너무 얇아지거나 허용 공차를 초과할 수 있습니다.
이러한 문제를 개선하거나 방지할 수 있는 방법이 있을까요? 바로 여기서 "동박 잔류율(Copper Coverage Rate)"의 개념이 등장합니다.
동박 잔류율이란 내층 회로 패턴이 전체 기판 면적에서 차지하는 비율을 의미합니다. 현재 레이어 동박 잔류율 = 동박 패턴 면적 / 전체 면적입니다.
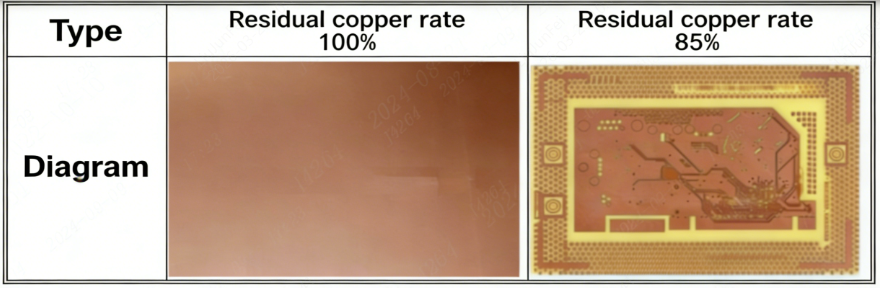
다층 기판 적층 공정 간략 개요:
1. 먼저 프리프레그를 작업 패널 크기에 맞게 절단합니다.
2. MI(제조 지시서) 및 적층 구조 요구사항에 따라 프리프레그, 코어 기판, 동박을 준비합니다.
3. 적층 후 고온·고압 진공 프레스에 투입하여 프리프레그의 수지를 녹이고 코어 기판의 동박 미도포 영역을 채웁니다. 냉각 후 수지가 경화되어 코어 기판과 동박이 결합됩니다.
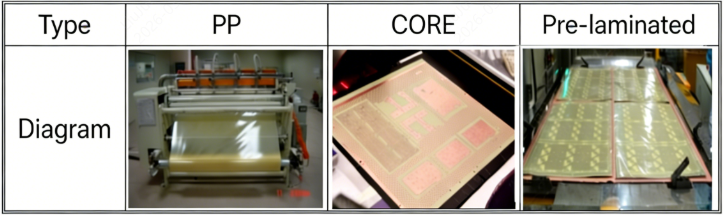
명백히, 동박 잔류율이 지나치게 낮은 기판은 완성 기판 두께가 얇은 쪽으로 치우치게 됩니다. 또한 동박 충전 부족으로 레이어 간 동박 분포가 불균일해져 기판이 뒤틀리기 쉽습니다. 설계 단계에서 패턴 분포를 최적화하면 이 문제를 근본적으로 해결할 수 있습니다.


특히 골드 핑거 기판에 대해 별도로 언급할 필요가 있습니다. 골드 핑거 기판은 카드 슬롯에 삽입되는 구조이기 때문에 두께에 매우 민감합니다. 기판이 너무 얇으면 삽입 시 헐겁거나 불안정하게 맞거나 전기적 접촉 불량이 발생할 수 있습니다.

따라서 다음을 강력히 권장합니다:
1) 골드 핑거가 있는 다층 기판의 경우, 빈 영역에 동박을 충전하세요. 특히 골드 핑거 영역에 해당하는 내층에는 반드시 동박 충전을 적용하여 기판이 슬롯에 확실하게 맞지 않을 만큼 얇아지는 것을 방지하고, 트레이스 폭 불균일 등의 불량을 예방해야 합니다.
2) 동박 잔류율이 25% 미만인 경우, 빈 영역에 동박 충전을 적용하여 불균일한 도금으로 인한 트레이스 폭 불균일을 줄이고 기판 두께의 과도한 편차를 방지하세요.


내층 및 외층의 골드 핑거 구간에는 솔더 마스크를 완전히 오픈하도록 설계해야 합니다(즉, 개별 골드 핑거 패드 사이에 솔더 마스크 브리지가 없어야 합니다). 이는 잦은 삽발 시 솔더 마스크가 카드 슬롯 안으로 떨어져 접촉 불량 등의 기능 문제를 일으키는 것을 방지합니다.
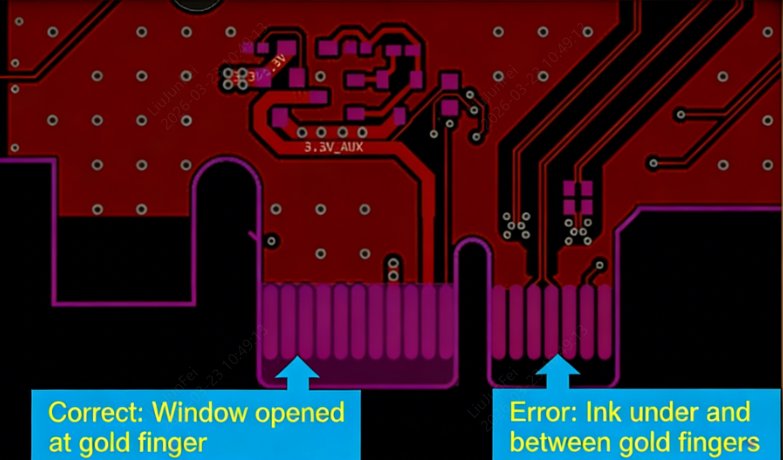
결론
기판 종류에 관계없이, 설계의 전기적 성능에 영향을 주지 않는 한 가능한 빈 영역에 동박 충전을 추가하는 것이 좋습니다. 특히 동박 잔류율이 25% 미만인 경우 동박 충전은 필수입니다.
또한 골드 핑거 설계에서는 골드 핑거에 해당하는 내층에 반드시 동박 충전을 적용해야 합니다. 외층 골드 핑거의 솔더 마스크 오픈은 골드 핑거 패드 사이나 골드 핑거 전단(前端)에 솔더 마스크 잔류물이 남지 않도록 설계해야 합니다.